
Теоретически, добиться работы в линейном режиме очень просто. Для этого достаточно подать на затвор напряжение определенной величины и следить за соблюдением требований документации, касательно области безопасной работы в прямом смещении (ОБР-П). В действительности же задача реализации силовой схемы, работающей в линейном режиме, является одной из самых непредсказуемых: многие простые решения демонстрируют такое поведение, что оно может стать кошмарным сном разработчика. В данной статье будут показаны «подводные камни» линейного режима работы и даны рекомендации и примеры реализации высоконадежных схем, работающих в линейном режиме. В описаниях в основном будет идти речь о силовых МОП-транзисторах, хотя все сказанное в равной мере может быть отнесено и к IGBT-транзисторам.
Проблемы линейного режима
Реализация силовой схемы, работающей в линейном режиме, связана с тремя фундаментальными вызовами:
1. Информация, приведенная в документации производителя, часто является неадекватной или даже некорректной по отношению к линейному режиму работы.
2. Тепловая неустойчивость ограничивает возможности силового транзистора, работающего в линейном режиме, по управлению нагрузкой относительно значений, которые следуют из паспортных максимальной рассеиваемой мощности или температуры перехода кристалла.
3. Пороговые напряжения и крутизна транзисторов с изолированным затвором (МОП и IGBT) могут существенно отличаться даже у однотипных транзисторов.
Тепловая неустойчивость и коэффициент передачи
Для управления током стока достаточно регулировать напряжение затвор-исток. Тем не менее, под влиянием некоторых различий температуры вдоль кристалла в нем возникает температурно-индуцированное изменение тока. Если температурно-зависимое изменение плотности тока окажется температурно-нестабильным (что нормально для линейного режима работы), то результатом может быть локальный разогрев и колебания тока в кристалле. Следствием разогрева может быть выход из строя, идентичный вторичному пробою биполярных транзисторов. Исходя из этого, границы действительной ОБР-П могут быть существенно меньшими, чем те, что получены только на основании тепловых сопротивлений, часто публикуемых в документации. Исключение возможности отказа является самым большим вызовом для разработки силовой схемы, работающей в линейном режиме. Таким образом, есть смысл в том, чтобы разобраться, что же вызывает выход из строя транзистора.
Работа в линейном режиме возможна в области «насыщения» передаточной характеристики (смежная с омической область), как показано на Рис. 1 .
|
|
| Рис. 1. Выходные характеристики МОП-транзистора. |
При работе в этой области ток стока зависит от напряжения затвор-исток VGS и от порогового напряжения VTH :
 , (1)
, (1)
где  ,
,
μe — подвижность электронов,
COZ — емкость оксидного слоя затвора,
W — ширина канала,
L — длина канала.
Коэффициент передачи и значение k тем выше, чем больше ширина канала W и чем меньше его длина L. Поскольку значение μe снижается по мере роста температуры, то рост температуры также вызовет снижение k. (Емкость не зависит от температуры, но зато зависит от напряжения сток-исток). Значение VTH тоже снижается с ростом температуры. Поскольку работа прибора в линейном режиме связана с его разогревом, то снижение подвижности электронов приведет к снижению тока стока, таким образом, поддерживая тепловую устойчивость. В противоположность этому, снижение порогового напряжения приводит к возрастанию тока стока. Таким образом, отрицательный температурный коэффициент порогового напряжения является фактором тепловой неустойчивости. Данные соотношения можно выразить математически. Для этого нужно продифференцировать (1) по температуре и выполнить подстановку в зависимость рассеиваемой мощности от температуры. В итоге получаем коэффициент устойчивости S:
 (2)
(2)
Чем выше значение S , тем большей тепловой неустойчивостью будет обладать транзистор. Это означает, что локальное возрастание температуры оказывает регенеративное влияние. Если же S имеет отрицательное значение, прибор будет температурно-устойчивым в линейном режиме. Обратите внимание, что значения ![]() и
и ![]() всегда отрицательны.
всегда отрицательны.
Пользуясь выражением (2) можно сформулировать факторы улучшения тепловой устойчивости (когда S имеет меньшие значения):
1. Снижение теплового сопротивления.
2. Снижение напряжения сток-исток.
3. Увеличение тока стока.
4. Снижение коэффициента передачи (а, следовательно, и k).
5. Снижение абсолютного значения температурного коэффициента порогового напряжения ![]() .
.
Факторы 4 и 5 полностью зависят от конструкции транзистора.
Таким образом, при его проектировании могут быть предприняты меры по улучшению тепловой устойчивости и, как следствие, и расширению области безопасной работы в линейном режиме. Таким мерам были подвергнуты серии линейных МОП-транзисторов и большинство РЧ МОП-транзисторов серий ARF компании Microsemi (ранее Advanced Power Technology).
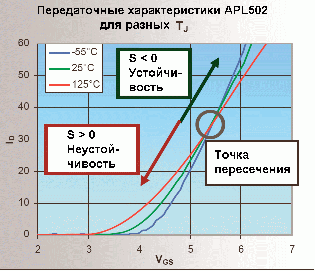
Рис. 2. Передаточные характеристики МОП-транзистора.
На Рис. 2 показаны передаточные характеристики МОП-транзистора для трех температур. На нем наглядно демонстрируется фактор тепловой устойчивости, описанный выражением (2). Существует одна точка, в которой пересекаются все кривые. Ниже этой точки преобладает влияние порогового напряжения и, поэтому, локальные изменения тока вызывают температурную неустойчивость. Выше этой точки преобладает влияние изменения коэффициента передачи и транзистор будет температурно-устойчивым.
Механизм отказа
Поскольку пересечение передаточных характеристик происходит в точке с относительно большим током, работа в линейном режиме ниже этой точки практически всегда сопровождается тепловой неустойчивостью. Проблема состоит в том, что в более разогретых областях кристалла выше плотность тока, что еще больше усиливает нагрев.
У любого МОП- или IGBT-транзистора имеется внутренний биполярный транзистор. Его коэффициент передачи возрастает при увеличении температуры прибора, а также при увеличении напряжения сток-исток. Сопротивление базы биполярного транзистора возрастает с нарастанием температуры, и снижается напряжение база-эмиттер. Учитывая данные факторы совместно следует вывод, что с ростом температуры повышается вероятность генерации напряжения на сопротивлении базы, достаточного для включения биполярного транзистора.
Таким образом, при определенном уровне нагретости кристалла может произойти отпирание расположенного в разогретой области биполярного транзистора. Вследствие этого работа в линейном режиме становится аварийной: разогрев становится необратимым, температура стремительно возрастает вплоть до перегорания аварийного участка, вызывающего закорачивание стока с истоком, а иногда и затвора с истоком. Некоторые поврежденные приборы еще могут работать в открытом состоянии, но после запирания они смогут работать только с напряжением, которое характеризуется большим током утечки, протекающим через поврежденную область.
Рекомендации по реализации линейного режима
Первым этапом проектирования надежной силовой схемы, работающей в линейном режиме, является налаживание контакта с инженером по применениям производителя транзистора. Он может дать бесценную информацию и советы, которые не публикуются в документации.
Вторым этапом является нахождение действительной ОБР-П для выбранных приборов. К сожалению, этот этап работы нельзя выполнить с помощью инструментов моделирования, т.к. модели полупроводниковых приборов не позволяют определить, когда же происходит его повреждение. Для нахождения рабочей ОБР-П потребуется тестирование на отказ нескольких приборов. Здесь можно воспользоваться преимуществами первого этапа, т.к. эта работа уже скорее всего была выполнена. После того, как были собраны данные, при каких напряжениях и токах возникали отказы, могут быть построены кривые или составлена математическая модель. Добавив небольшой запас надежности, получим действительную ОБР-П.
Табл. 1. Данные по отказам транзистора APT200GN60J при работе в линейном режиме
| VCE , В | IC , А | Р, Вт |
|---|---|---|
| 500 | 0.227 | 114 |
| 450 | 0.25 | 113 |
| 400 | 0.338 | 135 |
| 350 | 0.413 | 145 |
| 300 | 0.473 | 142 |
| 250 | 0.565 | 141 |
| 200 | 0.68 | 136 |
| 150 | 1 | 150 |
| 100 | 1.84 | 184 |
В Табл. 1 представлена информация по рассеиваемой мощности IGBT-транзистором APT200GN60J в линейном режиме, когда при фиксированном напряжении коллектор-эмиттер ток в линейном режиме возрастал вплоть до отказа транзистора. В результате в таблицу были внесены данные для нескольких напряжений коллектор-эмиттер.
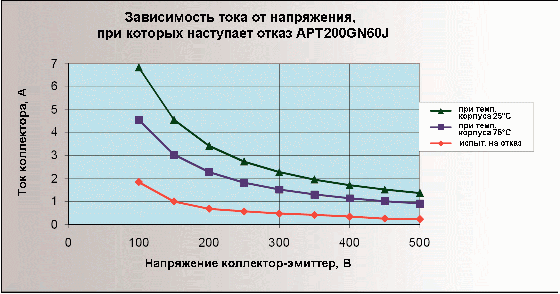
Рис. 3. Измеренные и теоретические ОБР-П
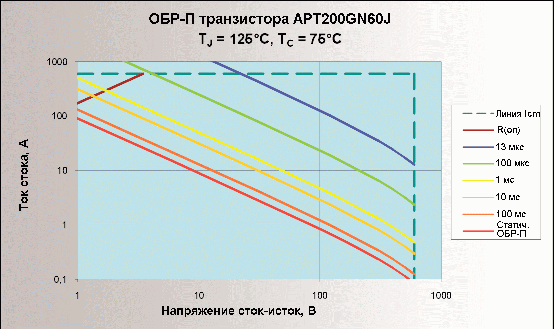
Рис. 4. Рабочие ОБР-П транзистора APT200GN60J
Транзисторы были смонтированы на теплоотводе с водяным охлаждением. Измеренная температура корпуса T C во время отказа составляла около 75°C . С помощью аппроксимирующей кривой можно оценить среднюю температуру перехода, при которой возникает отказ, — это примерно 175°C . Данная температура равна паспортной максимальной температуре перехода. Важно обратить внимание, что в линейном режиме отказ может произойти при средней температуре перехода, меньшей паспортного максимального значения.
На Рис. 3 проиллюстрированы данные из Табл. 1 , а также теоретические кривые ОБР-П, построенные из условий постоянства рассеиваемой мощности при температурах T J = 175°C и T C = 75°C и 25°C . Обратите внимание, насколько меньше действительная область ОБР-П, чем те, что получены расчетным путем на основании постоянства рассеиваемой мощности и ограниченные только тепловым сопротивлением (представлены кривыми для температур T C = 25°C и 75°C ). В большинстве документации публикуются кривые ОБР-П для температуры корпуса 25°C . Если полагаться на эти данные, то окажется что при больших напряжениях ток может быть в 6 раз больше, чем на самом деле способен пропустить транзистор!
Но даже если ориентироваться на более низкий ток, соответствующий температуре корпуса 75°C , он все одно окажется намного выше тока, при котором наступает отказ прибора вследствие локального разогрева. Решить эту проблему можно только одним способом: проверить несколько транзисторов с целью найти условия, вызывающие их повреждение.
На Рис. 3 показана аппроксимирующая кривая, построенная по результатам тестирования на отказ при протекании постоянного тока (статическая ОБР-П). Затем, пользуясь данными по переходным тепловым сопротивлениям, были построены ОБР-П при импульсном протекании тока (импульсные ОБР-П). Результат показан на Рис. 4. Полученные кривые являются рабочими ОБР-П транзистора APT200GN60J. Использование температуры перехода 125°C (ниже температуры, при которой происходит повреждение транзистора) позволяет создать некоторый запас надежности. Обратите внимание, если сопоставить кривую статической ОБР-П с кривой испытания на отказ на Рис. 3, то первая кривая окажется ниже. Именно так нужно поступать при использовании транзистора в линейном режиме, принимая запас минимум в 20°C относительно средней температуры перехода, при которой наступает отказ. На Рис. 4 за максимальную рекомендованную температуру перехода принята 125°C, т.о. запас надежности составляет 50°C относительно предельной температуры. Далее рассмотрим ОБР-П МОП-транзистора APL502J, который был специально разработан для работы в линейном режиме. Рабочие ОБР-П транзистора APL502J представлены на Рис. 5. По сравнению с APT200GN60J (Рис. 4) APL502J имеет более широкую ОБР-П. Границы ОБР-П находятся в противоречии с потерями проводимости. При полном включении и токе нагрузки 200А типичное значение напряжения коллектор-эмиттер APT200GN60J составляет всего лишь 1.7 В в разогретом состоянии (1.5В при комнатной температуре). Для сравнения более надежный транзистор APL502J при токе 26A и температуре 125°C характеризуется примерно в 6 раз большими потерями по сравнению с APT200GN60J.
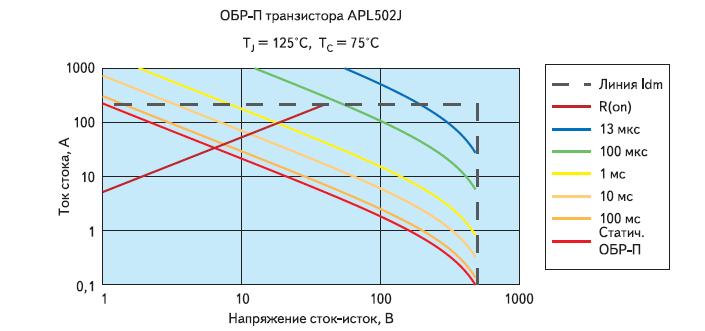
Рис. 5. Рабочие ОБР-П транзистора APL502J
Обратите внимание, что кривые ОБР-П на Рис. 4 и 5 загибаются в области повышенных напряжений (обе оси имеют логарифмический масштаб). Кривые ОБР-П, построенные на основании постоянства рассеиваемой мощности являются прямолинейными. Если в документации вы увидите прямолинейную ОБР-П для статического режима работы, будьте бдительны! Этот график скорее всего неадекватен линейному режиму.
Примеры применения транзисторов в линейном режиме
Твердотельное реле для коммутации постоянного тока
APT200GN60J прекрасно работает в составе твердотельных реле (ТТР), где обеспечивает ограничение тока заряда больших конденсаторных батарей за счет работы в линейном режиме, а затем переходит в полностью открытое состояние для минимизации потерь проводимости. Чтобы вписаться в пределы ОБР-П IGBT-транзистора необходимо существенно ограничить ток заряда емкости. Если к времени заряда нет строгих требований, то решение этой задачи не будет проблемой.
Требования
Рассмотрим ситуацию, когда необходимо зарядить конденсаторную батарею 1500 мкФ с напряжения 0В до 400В. Сколько будет длиться заряд емкости, значения не имеет. Для поддержания температуры корпуса ТТР на уровне 75°C или менее может потребоваться теплоотвод.
Решение
В соответствии с графиком ОБР-П (Рис.4) ток больше всего ограничивается при максимальном прикладываемом напряжении, которое в данном случае составляет 400 В. Из данных, которые использовались для создания Рис. 4 , следует, что безопасный ток заряда конденсаторов при напряжении 400 В составляет 0.16A (примерно вдвое меньше, чем ток в точке повреждения транзистора по данным из Табл. 1 , т.о. имеется хороший запас надежности). При токе заряда 0.16A заряд конденсаторной батареи с напряжения 0 В до 400 В произойдет за 3.75 секунды. Ускорить заряд конечно же можно, если, следуя по кривой ОБР-П, увеличивать ток заряда по мере нарастания напряжения на конденсаторе (т.е. когда снижается напряжение коллектор-эмиттер). Тем не менее, поскольку нам не предъявляются требования к времени заряда, вариант заряда постоянным током ввиду простоты схемного решения является более приемлемым.
Обеспечение работы транзистора в пределах ОБР-П для статического режима является решением только половины проблемы. Также необходимо оценить пиковое значение рассеиваемой мощности и результирующее пиковое значение температуры перехода. Поскольку ток заряда непрерывно поддерживается на постоянном уровне, то напряжение коллектор-эмиттер будет линейно снижаться с 400 В до практически 0 В, т.к. напряжение на конденсаторной батареи возрастает. Следовательно, рассеиваемая мощность достигает пикового значения на уровне 64 Вт (0.16A·400В) сразу после подачи напряжения, а затем будет линейно снижаться. Изменение рассеиваемой мощности во времени имеет треугольную форму.
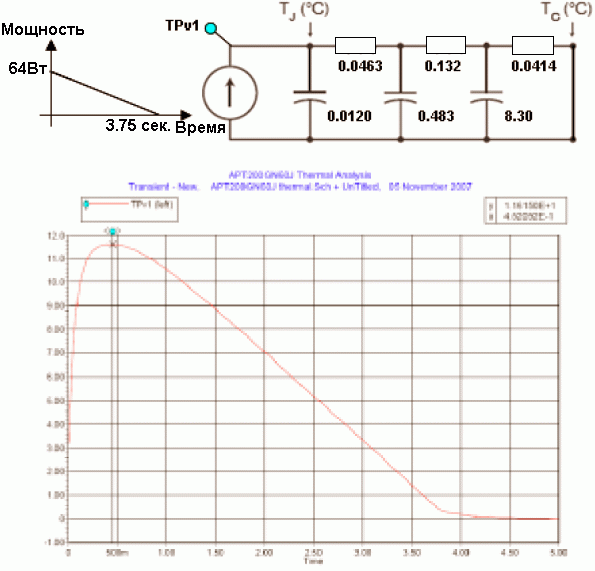
Рис. 6. Моделирование теплового переходного процесса
На Рис. 6 показан результат моделирования теплового переходного процесса, для чего использовалась RC-схема моделирования переходного теплового сопротивления транзистора APT200GN60J, на вход которой подавался линейно снижающийся импульс рассеваемой мощности с пиковым значением 64 Вт. Пиковое значение падения температуры между переходом и корпусом составляет около 12°C . Если температура корпуса достигнет 75°C , то средняя температура перехода должна приблизиться к 75°C + 12°C = 85°C , что существенно меньше предельно-допустимого значения 125°C.
Электронная нагрузка
Линейный МОП-транзистор APL502J хорошо работает в схемах, требующих более широкую ОБР-П, как, например, схема электронной нагрузки. В данном применении для удовлетворения требований по рассеиваемой мощности, а также по максимальному падению напряжения в открытом состоянии может потребоваться параллельное включение транзисторов.
Требования
В рассматриваемом примере наша самодельная нагрузка должна иметь рабочие диапазоны до 400Вт, 400В, 20А и перепад напряжения при полном открытии с током 20А не более 1В. С помощью теплоотвода можно добиться поддержания температуры корпуса на уровне не более 75°C .
Решение
Чтобы добиться температуры перехода менее 125°C воспользуемся кривыми ОБР-П, представленные на Рис. 5 . Вначале проверим, выполняется ли требование к полностью открытому состоянию. При комнатной температуре (и токе 26А) максимальное значение R DS(on) транзистора APL502J составляет 0.090 Ом. При температуре 125°C значение R DS(on) удваивается и составляет 0.180 Ом у каждого транзистора. Общее максимально-допустимое сопротивление равно 1В/20A = 0.050 Ом. Теперь, находим, какое минимальное число транзисторов позволят выполнить требование по падению напряжения в открытом состоянии: 0.180 Ом/ 0.050 Ом = 3.6, следовательно, необходимо минимум 4 транзистора. Обратите внимание, что при использовании токоизмерительных резисторов (об этом пойдет речь далее) падение напряжения на них также нужно учитывать при определении числа транзисторов.
Рассматривая ограничения ОБР-П можно найти минимальное значение мощности, которую можно рассеивать при наибольшем приложенном напряжении; в данном случае это 400 В. В случае APL502J с температурами корпуса и перехода, соответственно, 75°C и 125°C при напряжении 400 В максимальный ток равен 0.2А, а рассеиваемая мощность 80 Вт. Минимальное число транзисторов, которое необходимо для управления всей нагрузкой мощностью 400 Вт, составляет 400 Вт/80 Вт = 5 шт. Таким образом, все поставленные требования выполняются при параллельном включении минимум 5 транзисторов APL502J.
Может возникнуть мысль о параллельном включении транзисторов с добавлением к затвору каждого транзистора отдельного резистора (для предотвращения генерации) и контролем тока в одной точке. Но, к сожалению, реализация такой идеи несомненно привела бы к выходу из строя транзисторов.
Наконец, нам осталось ответить на последний вызов к разработке силовой схемы, работающей в линейном режиме, связанный с разбросом пороговых напряжений у однотипных транзисторов. В линейном режиме транзисторы нельзя напрямую соединять параллельно; каждый транзистор должен пропускать через себя отведенную ему долю общего тока. Добиться этого можно с помощью различных способов.
При условии, что это позволяет требование по максимальному падению напряжения в открытом состоянии, последовательно с каждым МОП-транзистором может быть включено достаточно большое сопротивление, на которые будет возложена существенная часть тепловой нагрузки (резисторы будут нагреваться). С помощью резисторов можно также добиться уравновешивания токов через МОП-транзисторы. Для этого между истоком каждого МОП-транзистора и возвратной линией цепи управления затвором должен быть предусмотрен отдельный резистор. Такое включение создает отрицательную обратную связь возле каждого затвора. Добиться идеального уравновешивания токов невозможно. Сортировка транзисторов по пороговому напряжению также не даст результата, т.к. даже незначительное различие МОП-транзисторов по пороговому напряжению приведет к существенному разбросу тока.
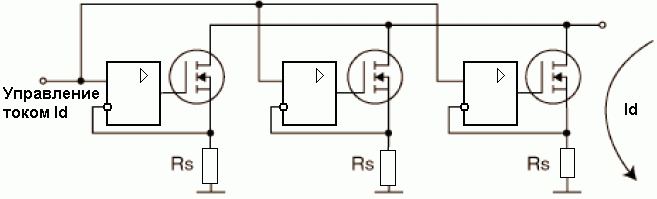
Рис. 7. Идея осуществления линейного режима при параллельном включении транзисторов
Поскольку рассматриваемая схема должна обладать малым падением напряжения в открытом состоянии, то эффективным в стоимостном плане может оказаться решение с раздельной стабилизацией тока у каждого МОП-транзистора с помощью усилительной схемы (управляет напряжением затвор-исток) и датчика тока. Данную идею иллюстрирует упрощенная схема на трех параллельно работающих МОП-транзисторах ( Рис .7) . Чтобы выполнить требование по малому общему падению напряжения в схеме нужно использовать низкоомные резисторы или датчики Холла.
Для упрощения сборки, и минимизации размеров и стоимости готового решения компания Microsemi выпустила серию приборов, предназначенных главным образом для работы в линейном режиме, но и способных работать в качестве коммутаторов. Данные приборы содержат в компактном корпусе SP1 силовой транзистор (линейный МОП- или Filed Stop IGBT-транзистор), токоизмерительный резистор (обладающий малой индуктивностью) и датчик температуры.

Рис. 8. Транзистор, токоизмерительный резистор и датчик температуры в одном корпусе SP1
Встроенный токоизмерительный резистор установлен на том же керамическом изоляторе, что и силовой транзистор, тем самым, минимизируя индуктивность и достигая охлаждения резистора, который при максимальной нагрузке рассеивает мощность всего лишь несколько Ватт. Такое решение упрощает одновременный контроль напряжения сток-исток, тока стока и температуры корпуса. В результате обработки данной информации в численном виде могут быть получены такие кривые ОБР-П, которые позволят более полно использовать возможности прибора и максимально снизить стоимость системы.
Скачать в PDF
Теоретически, добиться работы в линейном режиме очень просто. Для этого достаточно подать на затвор напряжение определенной величины и следить за соблюдением требований документации в области безопасной работы в прямом смещении (ОБР-П). В действительности же задача реализации силовой схемы, работающей в линейном режиме, — одна из самых непредсказуемых: многие простые решения проявляют себя так, что могут стать кошмарным сном разработчика. В данной статье будут показаны «подводные камни» линейного режима и даны рекомендации и примеры реализации высоконадежных схем, работающих в таком режиме. В описаниях в основном будет идти речь о силовых МОП-транзисторах, хотя все сказанное в равной мере может быть отнесено и к IGBT силовым транзисторам.
Теоретически, добиться работы в линейном режиме очень просто. Для этого достаточно подать на затвор напряжение определенной величины и следить за соблюдением требований документации в области безопасной работы в прямом смещении (ОБР-П). В действительности же задача реализации силовой схемы, работающей в линейном режиме, — одна из самых непредсказуемых: многие простые решения проявляют себя так, что могут стать кошмарным сном разработчика. В данной статье будут показаны «подводные камни» линейного режима и даны рекомендации и примеры реализации высоконадежных схем, работающих в таком режиме. В описаниях в основном будет идти речь о силовых МОП-транзисторах, хотя все сказанное в равной мере может быть отнесено и к IGBT силовым транзисторам.
Проблемы линейного режима
Реализация силовой схемы, работающей в линейном режиме, связана с тремя фундаментальными проблемами:
- Информация, приведенная в документации производителя, часто является неадекватной или даже некорректной по отношению к линейному режиму работы.
- Тепловая неустойчивость ограничивает возможности силового транзистора, работающего в линейном режиме, по управлению нагрузкой относительно значений, которые следуют из паспортных данных максимальной рассеиваемой мощности или температуры перехода кристалла.
- Пороговые напряжения и крутизна транзисторов с изолированным затвором (МОП и IGBT) могут существенно отличаться даже у однотипных транзисторов.
Тепловая неустойчивость и коэффициент передачи
Для управления током стока достаточно регулировать напряжение затвор-исток. Тем не менее, под влиянием некоторых различий температуры вдоль кристалла в нем возникает температурно-индуцированное изменение тока. Если температурно-зависимое изменение плотности тока окажется температурно-нестабильным (что нормально для линейного режима работы), то результатом может быть локальный разогрев и колебания тока в кристалле. Следствием разогрева может быть выход из строя, идентичный вторичному пробою биполярных силовых транзисторов. Исходя из этого, границы действительной ОБР-П могут быть существенно меньшими, чем те, что получены только на основании тепловых сопротивлений, часто публикуемых в документации. Исключение возможности отказа является самой большой проблемой при создании силовой схемы, работающей в линейном режиме. Таким образом, есть смысл в том, чтобы разобраться, что же вызывает выход силового транзистора из строя.
Работа в линейном режиме возможна в области «насыщения» передаточной характеристики (смежная с омической область), как показано на рис. 1.

Рис. 1. Выходные характеристики МОП-транзистора
При работе в этой области ток стока зависит от напряжения затвор-исток VGS и от порогового напряжения VTH:
![]()
где k = (μeCOZW)/2L, μe — подвижность электронов, COZ — емкость оксидного слоя затвора, W — ширина канала, L — длина канала.
Коэффициент передачи и значение k тем выше, чем больше ширина канала W и чем меньше его длина L. Поскольку значение μe снижается по мере роста температуры, то рост температуры также вызовет снижение k. (Емкость не зависит от температуры, но зато зависит от напряжения сток-исток). Значение VTH тоже снижается с ростом температуры. Поскольку работа прибора в линейном режиме связана с его разогревом, то снижение подвижности электронов приведет к снижению тока стока, таким образом, поддерживая тепловую устойчивость. В противоположность этому, снижение порогового напряжения приводит к возрастанию тока стока. Таким образом, отрицательный температурный коэффициент порогового напряжения является фактором тепловой неустойчивости. Данные соотношения можно выразить математически. Для этого нужно продифференцировать (1) по температуре и выполнить подстановку в зависимость рассеиваемой мощности от температуры. В итоге получаем коэффициент устойчивости S:

Чем выше значение S, тем большей тепловой неустойчивостью будет обладать силовой транзистор. Это означает, что локальное возрастание температуры оказывает регенеративное влияние. Если же S имеет отрицательное значение, прибор будет температурно-устойчивым в линейном режиме. Обратите внимание, что значения dVТН/dT и dk/dT всегда отрицательны.
Пользуясь выражением (2), можно сформулировать факторы улучшения тепловой устойчивости (когда S имеет меньшие значения):
- Снижение теплового сопротивления.
- Снижение напряжения сток-исток.
- Увеличение тока стока.
- Снижение коэффициента передачи (а следовательно и k).
- Снижение абсолютного значения температурного коэффициента порогового напряжения dVТН/dT.
Факторы 4 и 5 полностью зависят от конструкции силового транзистора. Таким образом, при его проектировании могут быть предприняты меры по улучшению тепловой устойчивости и, как следствие, расширению области безопасной работы в линейном режиме. Таким мерам были подвергнуты серии линейных МОП силовых транзисторов и большинство РЧ МОП силовых транзисторов серий ARF компании Microsemi (ранее Advanced Power Technology).
На рис. 2 показаны передаточные характеристики МОП транзистора для трех температур. На нем наглядно демонстрируется фактор тепловой устойчивости, описанный выражением (2). Существует одна точка, в которой пересекаются все кривые. Ниже этой точки преобладает влияние порогового напряжения, и поэтому локальные изменения тока вызывают температурную неустойчивость. Выше этой точки преобладает влияние изменения коэффициента передачи, и силовой транзистор будет температурно-устойчивым.

Рис. 2. Передаточные характеристики МОП-транзистора
Механизм отказа
Поскольку пересечение передаточных характеристик происходит в точке с относительно большим током, работа в линейном режиме ниже этой точки практически всегда сопровождается тепловой неустойчивостью. Проблема состоит в том, что в более разогретых областях кристалла выше плотность тока, что еще больше усиливает нагрев.
У любого МОП- или IGBT силового транзистора есть внутренний биполярный транзистор. Его коэффициент передачи возрастает при увеличении температуры прибора, а также при увеличении напряжения сток-исток. Сопротивление базы биполярного транзистора возрастает с нарастанием температуры, и снижается напряжение база-эмиттер. Учитывая данные факторы совместно, можно сделать вывод, что с ростом температуры повышается вероятность генерации напряжения на сопротивлении базы, достаточного для включения биполярного транзистора.
Таким образом, при определенном уровне нагретости кристалла может произойти отпирание расположенного в разогретой области биполярного транзистора. Вследствие этого работа в линейном режиме становится аварийной: разогрев становится необратимым, температура стремительно возрастает вплоть до перегорания аварийного участка, вызывающего закорачивание стока с истоком, а иногда и затвора с истоком. Некоторые поврежденные приборы еще могут работать в открытом состоянии, но после запирания они смогут работать только с напряжением, которое характеризуется большим током утечки, протекающим через поврежденную область.
Рекомендации по реализации линейного режима в силовых транзисторах
Первым этапом проектирования надежной силовой схемы, работающей в линейном режиме, является налаживание контакта с инженером по применениям компании-производителя силового транзистора. Этот специалист может дать бесценную информацию и советы, которых нет в документации.
Второй этап — это нахождение действительной ОБР-П для выбранных приборов. К сожалению, этот этап работы нельзя выполнить с помощью инструментов моделирования, так как модели полупроводниковых приборов не позволяют определить, когда же происходит его повреждение. Для нахождения рабочей ОБР-П потребуется тестирование на отказ нескольких приборов. Здесь можно воспользоваться преимуществами первого этапа, потому что эта работа уже скорее всего была выполнена. После того как были собраны данные, при каких напряжениях и токах возникали отказы, могут быть построены кривые или составлена математическая модель. Добавив небольшой запас надежности, получим действительную ОБР-П.
В таблице 1 представлена информация по рассеиваемой мощности IGBT силовым транзистором APT200GN60J в линейном режиме, когда при фиксированном напряжении коллекторэмиттер ток в линейном режиме возрастал вплоть до отказа силового транзистора. В результате в таблицу были внесены данные для нескольких напряжений коллектор-эмиттер.
| VCE, В | IC, А | Р, Вт |
| 500 | 0,227 | 114 |
| 450 | 0,25 | 113 |
| 400 | 0,338 | 135 |
| 350 | 0,413 | 145 |
| 300 | 0,473 | 142 |
| 250 | 0,565 | 141 |
| 200 | 0,68 | 136 |
| 150 | 1 | 150 |
| 100 | 1,84 | 184 |
Силовые транзисторы были смонтированы на теплоотводе с водяным охлаждением. Измеренная температура корпуса TC во время отказа составляла около 75 °C. С помощью аппроксимирующей кривой можно оценить среднюю температуру перехода, при которой возникает отказ, — это примерно 175 °C. Данная температура равна паспортной максимальной температуре перехода. Важно обратить внимание, что в линейном режиме отказ может произойти при средней температуре перехода, меньшей паспортного максимального значения.
На рис. 3 проиллюстрированы данные из таблицы 1, а также теоретические кривые ОБР-П, построенные из условий постоянства рассеиваемой мощности при температурах TJ = 175 °C и TC = 75 °C и 25 °C. Обратите внимание, насколько меньше действительная область ОБР-П, чем те, что получены расчетным путем на основании постоянства рассеиваемой мощности и ограниченные только тепловым сопротивлением (представлены кривыми для температур TC = 25 °C и 75 °C). В большинстве документов публикуются кривые ОБР-П для температуры корпуса 25 °C. Если полагаться на эти данные, то окажется, что при больших напряжениях ток может быть в 6 раз больше, чем на самом деле способен пропустить силовой транзистор!

Рис. 3. Измеренные и теоретические ОБР-П
Но даже если ориентироваться на более низкий ток, соответствующий температуре корпуса 75 °C, он все равно окажется намного выше тока, при котором наступает отказ прибора вследствие локального разогрева. Решить эту проблему можно только одним способом: проверить несколько силовых транзисторов, для того чтобы найти условия, вызывающие их повреждение.
На рис. 3 показана аппроксимирующая кривая, построенная по результатам тестирования на отказ при протекании постоянного тока (статическая ОБР-П). Затем, пользуясь данными по переходным тепловым сопротивлениям, были построены ОБР-П при импульсном протекании тока (импульсные ОБР-П). Результат показан на рис. 4. Полученные кривые являются рабочими ОБР-П силового транзистора APT200GN60J. Использование температуры перехода 125 °C (ниже температуры, при которой происходит повреждение силового транзистора) позволяет создать некоторый запас надежности. Обратите внимание, если сопоставить кривую статической ОБР-П с кривой испытания на отказ на рис. 3, то первая кривая окажется ниже. Именно так нужно поступать при использовании силового транзистора в линейном режиме, принимая запас минимум в 20 °C относительно средней температуры перехода, при которой наступает отказ. На рис. 4 за максимальную рекомендованную температуру перехода принято значение 125 °C, таким образом, запас надежности составляет 50 °C относительно предельной температуры.

Рис. 4. Рабочие ОБР-П транзистора APT200GN60J
Далее рассмотрим ОБР-П МОП транзистора APL502J, который был специально создан для работы в линейном режиме.
Рабочие ОБР-П силового транзистора APL502J представлены на рис. 5. По сравнению с APT200 GN60J (рис. 4) APL502J имеет более широкую ОБР-П. Границы ОБР-П находятся в противоречии с потерями проводимости. При полном включении и токе нагрузки 200 А типичное значение напряжения коллектор-эмиттер APT200GN60J составляет всего лишь 1,7 В в разогретом состоянии (1,5 В при комнатной температуре). Более надежный силовой транзистор APL502J при токе 26 A и температуре 125 °C характеризуется примерно в 6 раз большими потерями по сравнению с APT200GN60J.

Рис. 5. Рабочие ОБР-П транзистора APL502J
Обратите внимание, что кривые ОБР-П на рис. 4 и 5 загибаются в области повышенных напряжений (обе оси имеют логарифмический масштаб). Кривые ОБР-П, построенные на основании постоянства рассеиваемой мощности, являются прямолинейными. Если в документации вы увидите прямолинейную ОБР-П для статического режима работы, будьте бдительны! Этот график, скорее всего, неадекватен линейному режиму.
Примеры применения силовых транзисторов в линейном режиме
Твердотельное реле для коммутации постоянного тока
APT200GN60J прекрасно работает в составе твердотельных реле (ТТР), где обеспечивает ограничение тока заряда больших конденсаторных батарей за счет работы в линейном режиме, а затем переходит в полностью открытое состояние для минимизации потерь проводимости. Чтобы вписаться в пределы ОБР-П IGBT силового транзистора, необходимо существенно ограничить ток заряда емкости. Если к времени заряда нет строгих требований, то решение этой задачи не будет проблемой.
Требования
Рассмотрим ситуацию, когда необходимо зарядить конденсаторную батарею 1500 мкФ с напряжения 0 В до 400 В. Сколько будет длиться заряд емкости, значения не имеет. Для поддержания температуры корпуса ТТР на уровне 75 °C или менее может понадобиться теплоотвод.
Решение
В соответствии с графиком ОБР-П (рис. 4) ток больше всего ограничивается при максимальном прикладываемом напряжении, которое в данном случае составляет 400 В. Из данных, которые использовались для создания рис. 4, следует, что безопасный ток заряда конденсаторов при напряжении 400 В составляет 0,16 A (примерно вдвое меньше, чем ток в точке повреждения силового транзистора по данным из таблицы 1, таким образом, есть хороший запас надежности). При токе заряда 0,16 A заряд конденсаторной батареи с напряжения 0 В до 400 В произойдет за 3,75 с. Ускорить заряд, конечно же, можно, если, следуя по кривой ОБР-П, увеличивать ток заряда по мере нарастания напряжения на конденсаторе (то есть когда снижается напряжение коллектор-эмиттер). Тем не менее, поскольку нет требований по времени заряда, вариант заряда постоянным током ввиду простоты схемного решения более приемлем.
Обеспечение работы силового транзистора в пределах ОБР-П для статического режима — решение только половины проблемы. Необходимо оценить пиковое значение рассеиваемой мощности и результирующее пиковое значение температуры перехода. Поскольку ток заряда непрерывно поддерживается на постоянном уровне, то напряжение коллектор-эмиттер будет линейно снижаться с 400 В до практически 0 В, так как напряжение на конденсаторной батарее возрастает. Следовательно, рассеиваемая мощность достигает пикового значения на уровне 64 Вт (0,16 A, 400 В) сразу после подачи напряжения, а затем будет линейно снижаться. Изменение рассеиваемой мощности во времени имеет треугольную форму.
На рис. 6 показан результат моделирования теплового переходного процесса, для чего использовалась RC-схема моделирования переходного теплового сопротивления силового транзистора APT200GN60J, на вход которой подавался линейно снижающийся импульс рассеиваемой мощности с пиковым значением 64 Вт. Пиковое значение падения температуры между переходом и корпусом составляет около 12 °C. Если температура корпуса достигнет 75 °C, то средняя температура перехода должна приблизиться к 75 + 12 = 85 °C, что существенно меньше предельно-допустимого значения 125 °C.

Рис. 6. Моделирование теплового переходного процесса
Электронная нагрузка
Линейный МОП-транзистор APL502J хорошо работает в схемах, требующих более широкую ОБР-П, как, например, схема электронной нагрузки. В данном применении для удовлетворения требований по рассеиваемой мощности, а также по максимальному падению напряжения в открытом состоянии может понадобиться параллельное включение силовых транзисторов.
Требования
В рассматриваемом примере наша самодельная нагрузка должна иметь рабочие диапазоны до 400 Вт, 400 В, 20 А и перепад напряжения при полном открытии с током 20 А не более 1 В. С помощью теплоотвода можно добиться поддержания температуры корпуса на уровне не более 75 °C.
Решение
Чтобы добиться температуры перехода менее 125 °C, воспользуемся кривыми ОБР-П, они представлены на рис. 5. Сначала проверим, выполняется ли требование к полностью открытому состоянию. При комнатной температуре (и токе 26 А) максимальное значение RDS (on) силового транзистора APL502J составляет 0,090 Ом. При температуре 125 °C значение RDS (on) удваивается и составляет 0,180 Ом у каждого силового транзистора. Общее максимально-допустимое сопротивление равно 1 В/20 A = 0,050 Ом. Теперь находим, какое минимальное число силовых транзисторов позволит выполнить требование по падению напряжения в открытом состоянии: 0,180 Ом/0,050 Ом = 3,6. Следовательно, необходимо минимум 4 силовых транзистора. Обратите внимание, что при использовании токоизмерительных резисторов (об этом пойдет речь далее) падение напряжения на них также нужно учитывать при определении числа силовых транзисторов.
Рассматривая ограничения ОБР-П, определим минимальное значение мощности, которую можно рассеивать при наибольшем приложенном напряжении. В данном случае это 400 В. В случае применения APL502J с температурами корпуса и перехода, 75 °C и 125 °C соответственно, при напряжении 400 В максимальный ток равен 0,2 А, а рассеиваемая мощность 80 Вт. Минимальное число силовых транзисторов, которое необходимо для управления всей нагрузкой мощностью 400 Вт, составляет 400 Вт/80 Вт = 5 шт. Таким образом, все поставленные требования выполняются при параллельном включении минимум 5 силовых транзисторов APL502J.
Может возникнуть мысль о параллельном включении силовых транзисторов с добавлением к затвору каждого транзистора отдельного резистора (для предотвращения генерации) и контролем тока в одной точке. Но, к сожалению, реализация такой идеи, несомненно, привела бы к выходу из строя силовых транзисторов.
Наконец, нам осталось решить последнюю проблему при создании силовой схемы, работающей в линейном режиме. Она связана с разбросом пороговых напряжений у однотипных силовых транзисторов. В линейном режиме силовые транзисторы нельзя напрямую соединять параллельно; каждый силовой транзистор должен пропускать через себя отведенную ему долю общего тока. Добиться этого можно с помощью различных способов.
При условии, что это позволяет требование по максимальному падению напряжения в открытом состоянии, последовательно с каждым МОП-транзистором может быть включено достаточно большое сопротивление, на которое будет возложена существенная часть тепловой нагрузки (резисторы будут нагреваться). С помощью резисторов можно также добиться уравновешивания токов через МОП-транзисторы. Для этого между истоком каждого МОП-транзистора и возвратной линией цепи управления затвором должен быть предусмотрен отдельный резистор. Такое включение создает отрицательную обратную связь возле каждого затвора. Добиться идеального уравновешивания токов невозможно. Сортировка транзисторов по пороговому напряжению также не даст результата, так как даже незначительное различие МОП-транзисторов по пороговому напряжению приведет к существенному разбросу тока.
Поскольку рассматриваемая схема должна обладать малым падением напряжения в открытом состоянии, то эффективным в стоимостном плане может оказаться решение с раздельной стабилизацией тока у каждого МОП-транзистора с помощью усилительной схемы (управляет напряжением затвор-исток) и датчика тока. Данную идею иллюстрирует упрощенная схема на трех параллельно работающих МОП-транзисторах (рис. 7). Чтобы выполнить требование по малому общему падению напряжения, в схеме нужно использовать низкоомные резисторы или датчики Холла.
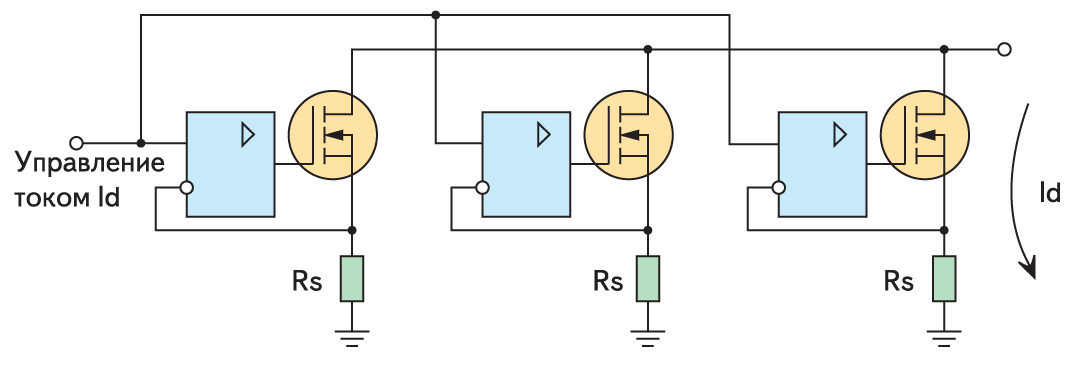
Рис. 7. Осуществление линейного режима при параллельном включении транзисторов
Для упрощения сборки и минимизации размеров и стоимости готового решения компания Microsemi выпустила серию приборов, предназначенных главным образом для линейного режима, но они способны работать и в качестве коммутаторов. Данные приборы содержат в компактном корпусе SP1 силовой транзистор (линейный МОП- или Filed Stop IGBT-транзистор), токоизмерительный резистор (обладающий малой индуктивностью) и датчик температуры.

Рис. 8. Транзистор, токоизмерительный
резистор и датчик температуры
в одном корпусе SP1
Встроенный токоизмерительный резистор установлен на том же керамическом изоляторе, что и силовой транзистор. Тем самым транзистор минимизирует индуктивность и достигает охлаждения резистора, который при максимальной нагрузке рассеивает мощность всего лишь несколько ватт. Такое решение упрощает одновременный контроль напряжения сток-исток, тока стока и температуры корпуса. В результате обработки данной информации в численном виде могут быть получены такие кривые ОБР-П, которые позволят более полно использовать возможности прибора и максимально снизить стоимость системы.
Использование IGBT в линейном режиме
Присоединяйтесь к обсуждению
Вы можете написать сейчас и зарегистрироваться позже.
Если у вас есть аккаунт, авторизуйтесь, чтобы опубликовать от имени своего аккаунта.
MOSFET транзисторы
Динамика включения MOSFET транзистора
Понятно, что будут рассматриваться лишь n-канальные MOSFET транзисторы, хотя все процессы одинаково справедливы и для их p-канальных сородичей. Эквивалентная схема MOSFET транзистор содержит в своем составе несколько емкостей (раздел «MOSFET-транзисторы»):
— емкость затвор-исток CGS;
— емкость затвор-сток CGD;
— емкость сток-исток CDS.
Эти емкости совместно с другими паразитными элементами оказывают основное влияние на процессы включения и выключения транзистора. Для понимания физики процессов коммутации и пояснения основных временных диаграмм напряжений и токов рассматривается режим коммутации задемпфированной индуктивной нагрузки как наиболее характерный для преобразовательной техники (задемпфированной — потому, что параллельно включен диод, и напряжение на ключе не превысит напряжение источника питания). Соответствующая электрическая схема с основными паразитными элементами представлена на рисунке DRV.1. Эквивалентом индуктивной нагрузки является источник постоянного тока с обратным диодом. Для упрощения считаем ничтожно малым фронт импульса управления на выходе драйвера. Ниже поэтапно представлен процесс включения MOSFET транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.2.

Рисунок DRV.1 — Эквивалентная электрическая схема коммутации индуктивной нагрузки с основными паразитными элементами
Процесс включения MOSFET транзистора состоит из нескольких стадий:
0) Выключенное состояние. На выходе драйвера нулевой уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.
1) Зарядка емкости затвора до напряжения открывания. На выходе драйвера появляется высокий уровень напряжения и начинается процесс заряда ёмкости затвор-исток CGS. Ток ограничивается лишь внутренним сопротивлением драйвера, внешним сопротивлением в цепи затвора и внутренним паразитным сопротивлением затвора транзистора.
Форма импульсов напряжения и токов соответствуют экспоненциальным кривым характерным для RC-цепочек. На протяжении этого периода транзистор пока еще закрыт.
2) Отрывание транзистора, линейный режим. Как только напряжение между затвором и истоком транзистора достигает порогового напряжения открывания UTH то транзистор начинает открываться и переходить в проводящее состояние. Это чисто линейный режим работы транзистора. На этой стадии уже начинает протекать небольшой ток через емкость затвор-сток CGD , называемую емкостью Миллера, что обусловлено падением напряжения на паразитных элементах (сопротивление и индуктивность стока). Напряжение на стоке транзистора практически не изменяется, т.к. протекающий ток еще слишком мал для того чтобы снизить напряжение на стоке до уровня запирания диода, стоящего в цепи источника тока. В течение этого этапа открывания ток через транзистор нарастает от нуля до максимума. В процессе роста тока происходит выделение тепла на кристалле транзистора. Транзистор постепенно переходит в режим называемый «плато Миллера».
3) «Плато Миллера». После нарастания тока через транзистор до максимума, диод, стоящий в цепи источника тока закрывается и напряжение на стоке транзистора начинает уменьшаться. Все бы было хорошо, но сток и затвор связаны емкостной связью. Из-за этого уменьшение напряжения на стоке приводит перезаряду емкости затвор-сток CGD за счет входного тока драйвера. Ёмкость CGD мала, но заряжена до большого напряжения. Процесс перезаряда забирает на себя весь ток драйвера и в течение этого периода напряжение на затворе не изменяется – временная диаграмма напряжения на затворе имеет вид плато – пресловутого «плато Миллера». Джон Мильтон Миллер — ученый, описавший это дело для электронных ламп. На этой стадии разряжается емкость сток-исток CDS и происходит процесс переключения — уменьшение напряжения на стоке. В условиях индуктивной нагрузки задемпфированной диодом снижение напряжения происходит при токе, уже достигшем номинального значения. На этой стадии происходят основные коммутационные потери на кристалле транзистора.
4) Зарядка емкости затвора до напряжения драйвера. После того как емкость Миллера окончательно перезарядится, ток драйвера вновь пойдет на заряд емкости затвор-исток CGS и напряжение на затворе снова начнет увеличиваться по тем же классическим уравнениям RC-цепочек. Процесс завершится после заряда CGS до напряжения питания драйвера.
5) Включенное состояние. На выходе драйвера максимальный уровень напряжения. Транзистор открыт. Ток протекает через транзистор. Все спокойно. Напряжение на транзисторе определяется падением напряжения на сопротивлении открытого канала. Все спокойно.

Рисунок DRV.2 — Основные этапы включения MOSFET-транзистора
Динамика выключения MOSFET транзистора
Процесс выключения MOSFET транзистора будет рассмотрен для условий, аналогичных вышеприведенным условиям для включения транзистора с той же эквивалентной схемой коммутации индуктивной нагрузки (рисунок DRV.3 схема). Ниже поэтапно представлен процесс выключения MOSFET транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.3.
Процесс выключения MOSFET транзистора состоит из нескольких стадий:
0) Включенное состояние. На выходе драйвера максимальный уровень напряжения (напряжение питания драйвера). Транзистор открыт. Ток протекает через транзистор. Все спокойно. Напряжение на транзисторе определяется падением напряжения на сопротивлении открытого канала. Все спокойно.
1) Разряд емкости затвора до напряжения плато Миллера. На этом этапе происходит разряд емкости затвора и емкости затвор-сток CGS (емкость Миллера) от максимального выходного напряжения драйвера до уровня при котором начинается рост напряжения на стоке и за счет емкостной связи напряжение на затворе устанавливается на некотором уровне – происходит выход на режим «плато Миллера».
2) «Плато Миллера». Закрывание транзистора приводит к росту напряжения на его стоке. Вследствие емкостной связи между стоком и затвором рост напряжения на стоке приводит к возникновению тока через емкость затвор-сток CGD. Величина этого тока ограничена суммарным сопротивлением затворной цепочки и максимальным входным током драйвера. Когда напряжение стока увеличивается до напряжения питания, то из-за «втекающего в драйвер» тока через емкость затвор-сток CGD напряжение на затворе транзистора не изменяется и временная диаграмма напряжения на затворе имеет вид плато – пресловутого «плато Миллера». На этой стадии заряжается емкость сток-исток CDS и происходит сам процесс выключения — рост напряжения на стоке до напряжения питания, В условиях индуктивной нагрузки ток через транзистор, поддерживаемый источником тока (индуктивность нагрузки) не изменяется. На этой стадии происходят основные коммутационные потери на кристалле транзистора.
3) Закрывание транзистора, линейный режим. После того как ток через емкость Миллера становится меньше разрядного тока драйвера напряжение на затворе начинает уменьшаться — сходит с «плато Миллера». К этому моменту напряжение на транзисторе практически достигает своего максимального значения (однако некоторый рост напряжения все же происходит – за счет увеличения напряжения не величину падения напряжения на диоде). Транзистор переходит в линейный режим и ток через него в течение этого интервала уменьшается до нуля. Ток через транзистор прекращается в момент, когда напряжение на затворе достигает порогового напряжения (напряжение открывания). На этой стадии также имеют место коммутационные потери на кристалле транзистора
4) Разрядка емкости затвора до минимального уровня напряжения драйвера. После того как емкость Миллера окончательно зарядится, ток драйвера полностью пойдет на разряд емкости затвор-исток CGS и напряжение на затворе уменьшиться до уровня минимального выходного напряжения драйвера.
5) Выключенное состояние. На выходе драйвера нулевой уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.

Рисунок DRV.3 — Основные этапы выключения MOSFET-транзистора
Основные выводы по процессу коммутации MOSFET
Анализ временных диаграмм включения/выключения MOSFET-транзистора позволяет сделать следующие практические выводы:
— включение и выключение транзистора происходит в несколько стадий, включающих задержку отклика на управляющее напряжение, собственно сам процесс коммутации и завершение переключения (дозаряд емкостей);
— скорость переключения транзистора пропорциональна входному и выходному току затвора определяемого цепью управления (драйвер, затворный резистор и т.д.); Ток затвора идет на перезарядку собственно емкости затвор-исток, а также паразитной ёмкости затвор-сток из-за которой и возникает «плато Миллера».
— собственно переключение транзистора и основные потери энергии на переключение происходят на этапе соответствующем «плато Миллера». Уменьшая длительность этой стадии можно уменьшить потери на переключение (в идеале…). Отсюда следует, что важно, чтобы драйвер выдавал достаточный входной и выходной ток при прохождении «плато Миллера». В остальных областях – предзаряд до порогового напряжения и постзаряд до выходного напряжения драйвера его выходной ток не оказывает существенного влияния на коммутационные потери.
— при условии ограничения максимального тока затвора внешним резистором ток затвора при включении (т.е. при заряде емкости затвора) больше чем ток затвора при выключении транзистора. То есть в обычных условиях процесс включения транзистора происходит быстрее процесса выключения транзистора. Это обусловлено тем, что заряд емкости затвора и емкости Миллера происходит через суммарную емкость затвора от напряжения примерно 10-15 В (обычный уровень напряжения питания драйвера). А разряд этих емкостей – при напряжении равном напряжению Миллера, т.е. примерно 5 В.
— частота коммутации ограничена сверху временными задержками на переключение транзистора. Для увеличения частоты коммутации необходимо снизить времена переключения ключевого элемента.
Все вышеприведенное относится к качественному рассмотрению процесса коммутации MOSFET. Хорошее описание процесса особенностей коммутации MOSFET дано в [Design And Application Guide For High Speed MOSFET Gate Drive Circuits. By Laszlo Balogh. в сети имеется сильно переработанный русскоязычный перевод – «Разработка и применение высокоскоростных схем управления силовыми полевыми транзисторами»]. Для практического расчета и конструирования источников питания необходим количественный расчет, основные соотношения которого приведены ниже.
IGBT транзисторы
Динамика включения IGBT транзистора
Динамика включения IGBT транзистора в целом схожа с динамикой включения MOSFETтранзистора, но имеет ряд специфических особенностей обусловленных его внутренней структурой. Из условной внутренней структуры (рисунок DRV.4) видно, что IGBT транзистор в своем составе содержит MOSFET транзистор и биполярный p-n-p транзистор.

Рисунок DRV.4 — Условное обозначение и эквивалентная упрощенная внутренняя структура IGBT-транзистора
Кроме внутренней структурной схемы для понимания динамических процессов коммутации IGBT также используют эквивалентную схему IGBT транзистора, содержащую в своем составе несколько емкостей (рисунок DRV.5):
— емкость затвор-эмиттер CGE;
— емкость затвор-коллектор CGC;
— емкость коллектор-эмиттер CCE.
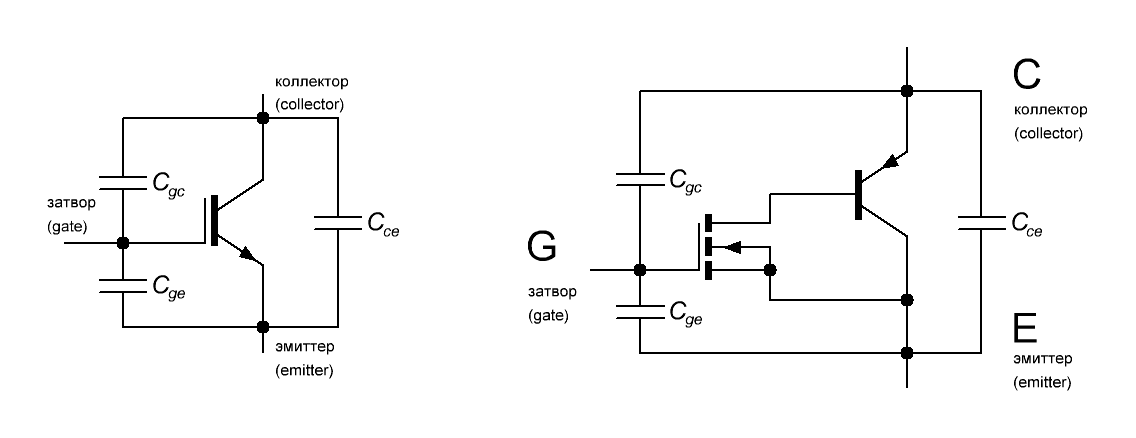
Рисунок DRV.5 — Паразитные емкости IGBT-транзистора
Эти емкости совместно с другими паразитными элементами оказывают основное влияние на процессы включения и выключения транзистора.
Для понимания физики процессов коммутации IGBT-транзистора и пояснения основных временных диаграмм напряжений и токов рассматривается режим коммутации задемфированной индуктивной нагрузки как наиболее характерный для преобразовательной техники. Этот же режим был рассмотрен и для вышеописанных процессов коммутации MOSFET-транзистора. Соответствующая электрическая схема с основными паразитными элементами представлена на рисунке DRV.6. Эквивалентом индуктивной нагрузки является источник постоянного тока с обратным диодом. Для упрощения считаем ничтожно малым фронт импульса управления на выходе драйвера. Кроме этого при управлении IGBT-транзисторами часто используются драйверы, обеспечивающие отрицательный уровень напряжения на затворе, что повышает скорость выключения и обеспечивает защиту от включения в случае резкого увеличения напряжения на затворе. Именно этот случай биполярного драйвера рассмотрен ниже. Ниже поэтапно представлен процесс включения IGBT-транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.7.
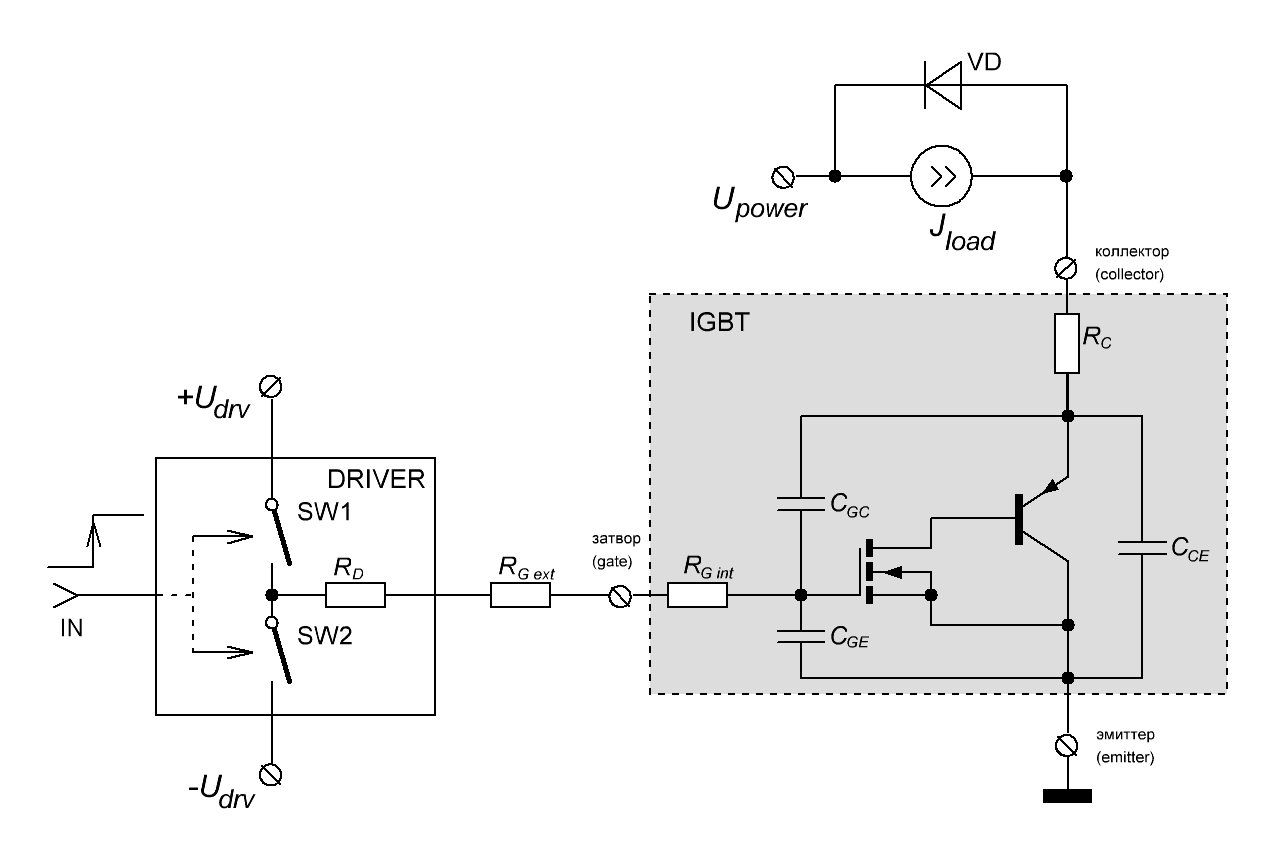
Рисунок DRV.6 — Эквивалентная электрическая схема коммутации индуктивной нагрузки IGBT-транзистором с основными паразитными элементами.
Процесс включения IGBT транзистора состоит из нескольких стадий:
0) Выключенное состояние. На выходе драйвера отрицательный относительно эмиттера уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.
1) Зарядка емкости затвор-эмиттер до напряжения открывания. На выходе драйвера появляется высокий уровень напряжения и начинается процесс заряда ёмкости затвор-эмиттер CGE. Ток ограничивается лишь внутренним сопротивлением драйвера, внешним сопротивлением в цепи затвора и внутренним паразитным сопротивлением затвора транзистора. Током драйвера происходит заряд емкости CGE и смена полярности напряжения на затворе. Форма импульсов напряжения и токов соответствуют экспоненциальным кривым характерным для RC-цепочек. На протяжении этого периода транзистор пока еще закрыт.
2) Отрывание транзистора, линейный режим. Как только напряжение между затвором и эмиттером транзистора достигает порогового напряжения открывания UTH то транзистор начинает открываться и переходить в проводящее состояние. При этом первым — включается «MOSFET» транзистор в составе IGBT. Через биполярный транзистор протекает существенно меньшая доля тока. Это чисто линейный режим работы IGBT транзистора. На этой стадии уже начинает протекать небольшой ток через емкость затвор-коллектор CGC, называемую емкостью Миллера, что обусловлено падением напряжения на паразитных элементах (сопротивление и индуктивность вывода коллектора). Напряжение на коллекторе транзистора практически не изменяется, так как протекающий ток еще слишком мал для того чтобы снизить напряжение на коллекторе до уровня запирания диода, стоящего в цепи источника тока (индуктивности). В течение этого этапа открывания транзисторы ток через транзистор нарастает от нуля до максимума. В процессе роста тока происходит выделение тепла на кристалле транзистора. Транзистор постепенно переходит в режим называемый «плато Миллера».
3) «Плато Миллера» — снижение напряжения на «MOSFET» транзисторе в составе IGBT. После нарастания тока через IGBT транзистор до максимума, диод, стоящий в цепи источника тока закрывается и напряжение на коллекторе транзистора начинает уменьшаться. Вследствие ёмкостной связи между коллектором и затвором уменьшение напряжения на коллекторе приводит перезаряду емкости затвор-коллектор CGC за счет входного тока драйвера. Процесс перезаряда забирает на себя весь ток драйвера и в течение этого периода напряжение на затворе не изменяется – временная диаграмма напряжения на затворе имеет вид плато – пресловутого «плато Миллера». Плато Миллера для IGBT транзистора состоит из двух стадий. На первой стадии происходит быстрое снижение напряжения коллекторе обусловленное снижением напряжения на «MOSFET» транзисторе в составе IGBT. На этой стадии имеют место большие коммутационные потери на кристалле транзистора. Вторая стадия плато Миллера — снижение напряжения на биполярном p-n-p транзисторе в составе IGBT. Далее.
4) «Плато Миллера» — снижение напряжения на биполярном p-n-p транзисторе в составе IGBT. После стадии быстрого спада напряжения на коллекторе, обусловленного снижением напряжения на «MOSFET» транзисторе начинается стадия более медленного спада обусловленного процессом завершения включения биполярного p-n-p транзистора в составе IGBT. Аналогично вследствие ёмкостной связи между коллектором и затвором уменьшение напряжения на коллекторе приводит перезаряду емкости затвор-коллектор CGC и в течение этого напряжение на затворе не изменяется – и плато Миллера продолжается до полного включения биполярного p-n-p транзистора после которого напряжение на IGBT устанавливается на уровне падения напряжения на открытом переходе транзистора. Это вторая стадия плато Миллера для IGBT транзистора. На этой стадии также имеют место коммутационные потери на кристалле транзистора.
5) Зарядка емкости затвора до напряжения драйвера. После того как емкость Миллера окончательно перезарядится, ток драйвера вновь пойдет на заряд емкости затвор-эмиттер CGEи напряжение на затворе снова начнет увеличиваться по тем же классическим уравнениям RC-цепочек. Процесс завершится после заряда CGE до напряжения питания драйвера. Практически весь ток полностью протекает через биполярный p-n-p транзистор в составе IGBT транзистора.
6) Включенное состояние. На выходе драйвера максимальный уровень напряжения. Транзистор открыт. Все спокойно. Напряжение на транзисторе определяется падением напряжения на переходе открытого транзистора. Все спокойно.

Рисунок DRV.7 — Основные этапы включения IGBT-транзистора
Динамика выключения IGBT транзистора
Процесс выключения IGBT транзистора будет рассмотрен для условий аналогичных вышеприведенным условиям для эквивалентной схемы коммутации индуктивной нагрузки. Поэтапно ниже представлен процесс выключения IGBT транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.8.
Процесс выключения IGBT транзистора.
0) Включенное состояние. На выходе драйвера максимальный уровень напряжения (напряжение питания драйвера). Транзистор открыт. Ток протекает через транзистор. Все спокойно. Напряжение на транзисторе определяется падением напряжения на сопротивлении открытого канала. Все спокойно.
1) Разряд емкости затвора до напряжения плато Миллера. На этом этапе происходит разряд емкости затвора и емкости затвор-сток CGE (емкость Миллера) от максимального выходного напряжения драйвера до уровня при котором начинается рост напряжения на коллекторе и за счет емкостной связи напряжение на затворе устанавливается на некотором уровне – происходит выход на режим «плато Миллера». Важно понимать, что для IGBTтранзистора имеется значительная разница между напряжениями на «плато Миллера» для включения и выключения. Это обусловлено задержкой подключения обратной связи, так как биполярная часть IGBT транзистора достаточно «тормозная» и рост напряжения на коллекторе начинается уже после того как напряжение успело спасть до напряжения несколько ниже порога включения.
2) «Плато Миллера». Закрывание IGBT транзистора приводит к росту напряжения на его коллекторе. Вследствие емкостной связи между коллектором и затвором рост напряжения на стоке приводит к возникновению тока через емкость коллектор-сток CGC. Величина этого тока ограничена суммарным сопротивлением затворной цепочки и максимальным входным током драйвера. Вследствие этого тока обратной связи напряжение на затворе транзистора не изменяется во время пока напряжение на транзисторе увеличивается. То есть ток драйвера и «ток Миллера» друг друга полностью компенсируют, при этом временная диаграмма напряжения на затворе имеет вид «плато Миллера». На этой стадии заряжается емкость коллектор-эмиттер CCE и происходит сам процесс выключения — рост напряжения на коллекторе до напряжения питания. Ток через транзистор, поддерживаемый источником тока (цепь нагрузки), не изменяется. На этой стадии происходят основные коммутационные потери на кристалле транзистора. При этом важно понимать, что на этой стадии ток перераспределяется между обоими транзисторами, входящими в состав IGBT — «MOSFET» транзистором и p-n-p BT-транзистором.
3) Закрывание транзистора, выключение «MOSFET» транзистора в составе IGBT. После того как ток через емкость Миллера становится меньше разрядного тока драйвера напряжение на затворе начинает уменьшаться (сход с «плато Миллера»). К этому моменту напряжение на транзисторе практически достигает своего максимального значения. Далее следует быстрое уменьшение тока через транзистор до определенной величины – происходит выключение — «MOSFET» транзистора в составе IGBT. Напряжение на затворе продолжает спадать.
4) Перезарядка емкости затвора до минимального уровня напряжения драйвера. После того как емкость Миллера окончательно зарядится, ток драйвера полностью пойдет на разряд емкости затвор-эмиттер CGE и напряжение на затворе снизится уровня минимального выходного напряжения драйвера (отрицательного относительно «земли», как правило).
4-5) Закрывание транзистора, выключение биполярного p-n-p транзистора в составе IGBT.
После стадии быстрого спада тока транзистора, обусловленного выключением «MOSFET» транзистора в составе IGBT начинается стадия более медленного спада тока, обусловленного выключением биполярного p-n-p транзистора в составе IGBT. Это так называемый «токовый хвост». Длина «хвоста» определяется типом транзистора и величиной ранее протекавшего тока. На этой стадии также происходят существенные коммутационные потери.
6) Выключенное состояние. На выходе драйвера минимальный уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.

Рисунок DRV.8 Основные этапы выключения IGBT-транзистора
Основные выводы по процессу коммутации IGBT
Из временных диаграмм видно, что в целом процесс включения/выключения IGBTтранзистора схож с процессом коммутации MOSFET транзистора. Таким образом, выводы сделанные выше для MOSFET применимы и для IGBT. Однако имеются некоторые основные отличия в процессе коммутации IGBT. Выделим их:
— наличие ступенчатого спада напряжения на коллекторе в процессе включения, что обусловлено составным характером IGBT транзистора: сначала включается MOSFET-часть, затем биполярная часть;
— наличие ступенчатого спада тока на коллекторе в процессе выключения, что также обусловлено составным характером IGBT транзистора: сначала выключается MOSFET-часть, затем биполярный транзистор. К тому же процесс выключения биполярного p-n-p транзистора затягивается и имеет место так называемый «токовый хвост». Опасность «хвоста» проявляется в значительных сквозных токах при включении IGBT в схему полумоста.
— уровни «плато Миллера» для включения и выключения транзистора различны. При включении IGBT уровень «плато Миллера» больше чем уровень «плато Миллера» при выключении. Это обусловленной временной задержкой включения отрицательной обратной связи между коллектором и затвором.
— IGBT транзистор более медленный по сравнению с MOSFET.
Все вышеприведенное относится к качественному рассмотрению процесса коммутации IGBT транзистора. Хорошее описание процесса особенностей коммутации IGBT дано в [Markus Hermwille. IGBT Driver Calculation. Application Note AN-7004, SEMIKRON International. Русскоязычный перевод в журнале «Электронные компоненты №6, №8. 2008 — Управление изолированным затвором. Часть 1, Часть 2. Маркус Хермвиль, Андрей Колпаков.]. Проблемы потерь при переключении описаны в [DRIVE CIRCUITS FOR POWER MOSFETs AND IGBTs. by B. Maurice, L. Wuidart. APPLICATION NOTE. STMicroelectronics]. Принципы управления MOSFET и IGBT представлены в статье [Управление изолированными затворами MOSFET/IGBT, базовые принципы и основные схемы. Винтрич Арендт, Николаи Ульрих, Райманн Тобиас, Турски Вернер. Силовая электроника, №5, 2013]. Для практического расчета и конструирования источников питания необходим количественный расчет, основные соотношения которого приведены ниже.
Расчет параметров цепи управления MOSFET-транзисторов
Для определения требований к цепи управления MOSFET необходим расчет основных электрических параметров в цепи затвора транзистора. В целом нижеприведенные соотношения справедливы и для расчета управления IGBT-транзисторов.
Заряд затвора
Основным параметром, используемым при расчете цепей управления MOSFET является заряд затвора QG. Он приводится в справочных листах (datasheet) на транзисторы. Кроме численного значения, которое можно найти в datasheet, важно понимать, что QG зависит от напряжения на транзисторе VDS. Зависимости напряжения на затворе VGS от «вкачанного» в него заряда QG также приводятся в datasheet. В качестве примера на рисунке DRV.9 представлена зависимость для популярного транзистора IRF740. Видно, что зависимость содержит отражение «плато Миллера».
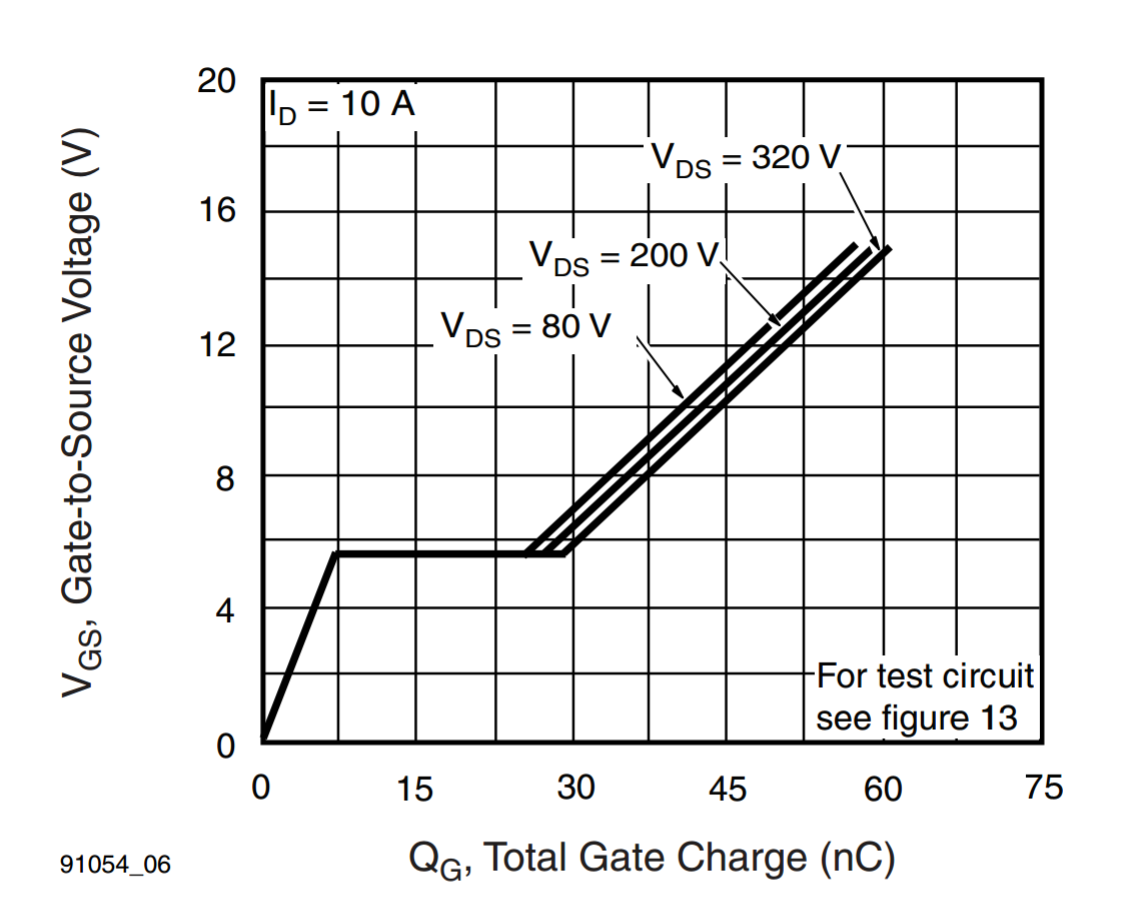
Рисунок DRV.9 — Зависимость напряжения на затворе от заряда затвора для популярного транзистора IRF740 (по данным datasheet от Vishay Siliconix)
В соответствии графиком можно определить весьма точно величину суммарного заряда затвора при заданном напряжении драйвера и напряжении VGS на транзисторе.
Мощность управления
Выражение для мощности управления затвором PG_avg имеет вид:

где:
Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
QG — заряд затвора (total gate charge);
f – частота коммутации.
Эта мощность рассеивается на резистивных элементах цепи управления – затворном резисторе, внутреннем сопротивлении драйвера, паразитном сопротивлении затвора.
Средний ток управления MOSFET
Средний ток IG_avg, потребляемый схемой управления на перезаряд емкости затвора равен:

где:
QG — заряд затвора (total gate charge);
f – частота коммутации.
Это было среднее значение. Теперь раскладываем импульс тока управления по полочкам, находим токи на каждом из интервалов и длительности интервалов.
Напряжение «плато Миллера»
Напряжение «плато Миллера» VMiller определяется выражением:

где:
VTH – пороговое напряжение (открывания транзистора);
ID_max – максимальный ток стока;
gfs – крутизна зависимости тока стока от напряжения затвора на малом сигнале:

Как правило, вторая компонента суммы, обусловленная крутизной gfs значительно меньше VTH по величине и на практике её можно не учитывать.
Токи и времена коммутации на стадии включения
Токи:
— амплитуда импульса тока затвора IG_max (в начальный момент времени) равна:

где:
Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
Rdriver_ON – внутреннее сопротивление драйвера на стадии включения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
В случае если выходной каскад драйвера работает как генератор тока, то максимальный ток равен максимальному выходному току драйвера.
— ток затвора в линейном режиме IG_lin — в период времени между VTH и VMiller равен:

где:
VMiller – напряжение на «плато Миллера»;
VTH – пороговое напряжение включения транзистора.
Смысл полсуммы заключается в усреднении VTH и VMiller для получения среднего значения напряжения на интервале.
— ток затвора на «плато Миллера» IG_Miller равен:

Длительности:
— длительность времени нарастания напряжения до порога открывания VTH (в первом приближении):

где:
Ciss — входная емкость (Input Capacitance).
— длительность линейного режима (период времени между VTH и VMiller):

где:
Ciss — входная емкость (Input Capacitance).
На практике длительность этого интервала достаточно мала (поскольку VTH≈VMiller) и может быть исключена из расчета.
— длительность «плато Миллера»:

где:
Crss — проходная емкость (Reverse Transfer Capacitance).
VDS – напряжение сток-исток на выключенном транзисторе.
Смысл этого выражения заключается в том, что ток на «плато Миллера» фактически перезаряжает «ёмкость Миллера» Crss заряженную до напряжения сток-исток выключенного транзистора.
Особенно важным интервалом является интервал соответствующий «плато Миллера» поскольку именно на этом интервале происходят основные коммутационные потери.
Для упрощения расчетов по вышеприведенным соотношениям можно допустить, что:

При этом длительность линейного режима обращается в ноль и исключается из расчета. Таким образом, время спада напряжения на транзисторе в момент включения tf определяетсядлительностью «плато Миллера»:

или упрощая:

где:
Crss — проходная емкость (Reverse Transfer Capacitance), зависит от напряжения сток-исток VDS;
VDS – напряжение сток-исток на выключенном транзисторе;
Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
VMiller – напряжение на «плато Миллера», практически равно VTH – пороговому напряжению включения транзистора;
Rdriver_ON – внутреннее сопротивление драйвера на стадии включения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
Токи и времена коммутации на стадии выключения
— амплитуда импульса тока затвора в начальный момент времени выключения транзистора равна:

где:
Rdriver_OFF – внутреннее сопротивление драйвера на стадии выключения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
В случае если выходной каскад драйвера работает как генератор тока, то максимальный ток равен максимальному выходному току драйвера.
— ток затвора на «плато Миллера» на стадии выключения транзистора равен:

— ток затвора в линейном режиме — период времени между VTH и VMiller равен:

где:
VMiller – напряжение на «плато Миллера»;
VTH – пороговое напряжение включения транзистора.
Времена:
— длительность времени спада напряжения до напряжения VMiller «плато Миллера» (в первом приближении):

— длительность «плато Миллера»:

— длительность линейного режима (период времени между VTH и VMiller):

На практике длительность этого интервала достаточно мала (поскольку VTH≈VMiller) и может быть исключена из расчета.
Таким образом, время нарастания напряжения на транзисторе при переходе в закрытое состояние tr определяется длительностью «плато Миллера»:

или упрощая:

где:
Crss — проходная емкость (Reverse Transfer Capacitance), зависит от напряжения сток-исток VDS;
VDS – напряжение сток-исток на выключенном транзисторе;
Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
VMiller – напряжение на «плато Миллера», практически равно VTH – пороговому напряжению включения транзистора;
Rdriver_OFF – внутреннее сопротивление драйвера на стадии выключения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
Основные коммутационные потери транзистора происходят именно на интервале, соответствующему «плато Миллера».
Шунтирующий конденсатор драйвера. Расчет
Выше показано, что управление MOSFET транзистором в ключевом режиме осуществляешься импульсами тока, перезаряжающего паразитные емкости. Амплитуда этих импульсов может составлять единицы ампер при временах нарастания – менее 100 нс. Из этого следует, что для формирования данных импульсов драйвер должен иметь источник энергии с малым внутренним сопротивлением, причем расположенный в непосредственной близости от драйвера.
Таким источником энергии является шунтирующий конденсатор драйвера, за счет энергии которого осуществляется питание драйвера в моменты коммутации. Для этой ответственной роли подходят только керамические конденсаторы. Вопрос в том какова должна быть минимальная емкость шунтирующего конденсатора? При закачивании в затвор суммарного заряда затвора QG напряжение на шунтирующем конденсаторе изменится на величину ΔVCdrv :

где:
QG – суммарный заряд затвора;
CDRV – емкость шунтирующего конденсатора.
Отсюда следует выражение для емкости шунтирующего конденсатора CDRV:

где:
QG – суммарный заряд затвора;
ΔVCdrv – допустимые пульсации на шунтирующем конденсаторе.
Таким образом, для расчета величины емкости необходимо задаться величиной допустимых пульсаций на шунтирующем конденсаторе. Они могут быть выбраны в пределах 2-5 %.
Расчет (определение) внутреннего сопротивления драйвера
Внутреннее выходное сопротивление драйвера на стадии включения Rdriver_ON, если не указано в datasheet, может быть вычислено по соотношению:

где:
Vdriver – номинальное напряжение драйвера;
Idriver_max_ON – максимальный выходной ток драйвера на стадии включения.
Аналогично рассчитывается внутреннее входное сопротивление драйвера на стадии выключения Rdriver_OFF :

где:
Vdriver – номинальное сопротивление драйвера;
Idriver_max_OFF – максимальный входной ток драйвера на стадии выключения.
Выбор оптимального сопротивления затворного резистора
Критерий демпфирования осцилляций
Цепь, или вернее токовая петля, по которой протекает ток управления транзистором (ток затвора) имеет собственную индуктивность. Эта индуктивность во-первых замедляет рост тока в цепи затвора, во-вторых – приводит к появлению высокочастотных осцилляций в цепи затвора обусловленных LC-контуром, образованном емкостью затвора и паразитной индуктивностью цепи. Прямым путем решения проблем является оптимизация разводки печатной платы с целью уменьшения паразитных индуктивностей там, где они не нужны. Но в любом случае уменьшить индуктивность до нуля не получится.
Для демпфирования осцилляций используется внешний резистор затвора. Его величинаRG_extвыбирается исходя из соотношения [Design And Application Guide For High Speed MOSFET Gate Drive Circuits. By Laszlo Balogh. В сети имеется сильно переработанный русскоязычный перевод – «Разработка и применение высокоскоростных схем управления силовыми полевыми транзисторами»]:

где:
LS – паразитная индуктивность контура;
Сiss – входная емкость транзистора;
RG_int – паразитное сопротивление затвора транзистора;
Rdriver – внутреннее сопротивление (среднее) драйвера:

Физический смысл этого соотношения для нахождения оптимального сопротивления контура заключается в том, чтобы сделать активное сопротивление затворного резистора равным удвоенному волновому сопротивлению LC контура. При этом колебания эффективно демпфируются.
Критерий ограничения тока драйвером
Для каждого типа драйвера существует максимальное значение входного и выходного тока. Это накладывает ограничения на минимальную величину сопротивления в цепи затвора ниже которой оно не оказывает существенного значения на динамические характеристики, т.к. ток ограничивается уже самим драйвером.
В общем случае (пренебрегаем паразитным сопротивлением затвора и ограничением тока драйвером) максимальное значение импульса тока затвора IG_max равно:

где :
Vdriver – максимальное выходное напряжение драйвера;
RG_ext – сопротивление затворного резистора.
Приравнивая максимальное значение импульса тока затвора IG_max к максимальному значению тока драйвера Idriver_max :

Получаем минимальную величину сопротивления затвора RG_ext:

где :
Vdriver – максимальное выходное напряжение драйвера;
Idriver_max – максимальное значение тока драйвера (выбирается как минимальное из Idriver_max_ON и Idriver max OFF).
Выбирая затворное сопротивление больше данной величины уменьшают скорость переключения транзистора. Зачем необходимо уменьшать скорость переключения транзистора – см. далее.
Критерий устойчивости к высоким dV/dt на закрытом транзисторе
Существует предельно допустимая скорость нарастания напряжения на закрытом транзисторе, иначе он может приоткрыться (об этом ниже в подразделе «Высокие скорости нарастания напряжения на транзисторе (dV/dt) – причины и следствия»).
Предельно допустимая скорость нарастания напряжения прикладываемого к закрытому транзистору (dV/dt)max определяется по соотношению:

где:
VTH – напряжение открывания драйвера (берется с учетом рабочей температуры);
CGD – емкость затвор-сток;
RG_total – суммарное сопротивление затвора:

где:
RG_ext – выбранное значение сопротивление затворного резистора;
RG_int – паразитное сопротивление затвора транзистора;
Rdriver_OFF – внутреннее сопротивление драйвера в состоянии OFF (соотношение для расчета представлено выше).
Если рассчитанное значение (dV/dt)max больше реальной скорости роста напряжения в данной схеме (dV/dt)real, то все в порядке. Если же нет, то скорость роста напряжения нужно уменьшить или уменьшить суммарное сопротивление затвора RG_total.
Критерий заданного времени включения/выключения транзистора
В ряде случаев необходимо искусственно замедлить скорость коммутации транзистора. Необходимость этого может быть обусловлена снижением dV/dt в схеме, ограничению броска тока при коммутации снижением уровня наводок и т.д. В этом случае увеличением величины затворного резистора добиваются повышения времени коммутации в соответствии с соотношением:

где dV/dt – заданная скорость нарастания напряжения.
Высокие скорости нарастания напряжения на транзисторе (dV/dt) – причины и следствия
Причины высоких dV/dt на закрытом транзисторе и последствия
В большинстве схемотехнических решений преобразователей используется последовательное соединение двух поочередно включающихся силовых ключей MOSFET или IGBT-транзисторов. К таким схемам относятся схемы полумостовых, мостовых преобразователей, синхронных выпрямителей, системы управления двигателями и др. С целью уменьшения динамических потерь необходимо увеличивать скорости переключения силовых ключей. Динамические потери при этом уменьшаются, но возникает опасность «несанкционированного» включения транзистора за счет тока, протекающего через емкость затвор-сток. Включение может быть как полным, так и может быть переход в линейный режим. Следствие этого включения – «сквозняк» — сквозной ток через оба силовых транзистора и выход преобразователя из строя.
Кроме этих типичных случаев, высокие dV/dt на транзисторе могут возникать при:
— включении питания преобразователя (когда еще драйвер «молчит»);
— резком разрыве тока в индуктивностях силовой схемы;
— резонансных явлениях.
С особым вниманием следует отнестись к устройствам, работа которых предполагает значительный нагрев силовых ключей. Рост температуры кристалла приводит к уменьшению порогового напряжения открывания транзистора.
При проектировании преобразовательной техники необходимо определить входит ли конкретная схема в группу риска. Необходимо понимать, что емкости затвор-сток и затвор-исток образуют емкостной делитель, максимальное выходное напряжение на котором (напряжение на затворе) при любой скорости роста напряжения dV/dt не превысит величины:

где :
VGS_max – максимальное напряжение на затворе;
VDS_max – максимальное напряжение на транзисторе (сток-исток), или максимально возможное напряжение на транзисторе;
CGS – емкость затвор-исток;
CGD – емкость затвор-сток.
Если напряжение VGS_max окажется меньше порогового напряжения открывания транзистора VTH :

то в данных условиях схема находится вне зоны риска по dV/dt.
Если наоборот:

то необходимо принимать дополнительные меры, о которых указано ниже.
Риск «паразитного включения» существенно возрастает с ростом рабочего напряжения на стоке. Вместе с тем при малых рабочих напряжениях (как правило, менее 24 В) случайного открывания транзистора по причине высоких dV/dt можно не опасаться.
Способы защиты от высоких значений dV/dt
Резистор в цепи затвор-исток
Использование резистора подключаемого параллельно затвору и истоку транзистора «помогает» лишь при сравнительно малых скоростях роста напряжения на транзисторе. Однако это весьма действенный способ устранения «паразитного включения» при подаче питания на устройство. Дело в том, что при подаче питания некоторые драйверы могут еще находится в спящем режиме и его выходные каскады могут быть в неактивном состоянии и не «притягивать» затвор к земле. В этот период времени пассивный способ с помощью резистора обеспечивает защиту затвора. Величина резистора RGSвыбирается исходя из соотношения:

где :
VTH – напряжение открывания драйвера (берется с учетом рабочей температуры);
CGD – емкость затвор-сток;
dV/dt – скорость роста напряжения на транзисторе.
Разрядный резистор физически необходимо располагать непосредственно вблизи силового ключа. Недостатком способа является значительная дополнительная нагрузка на выходной каскад драйвера в течение всего импульса открытого состояния ключа.
Схема на p-n-p транзисторе
Схема на p-n-p транзисторе (см. рисунок DRV.14), ускоряющая выключение транзистора так же эффективна для защиты транзистора от включения в результате действия больших dV/dt. При использовании схемы максимальная скорость нарастания напряжения на силовом MOSFETопределяется из соотношения:

где:
VTH – напряжение открывания драйвера (берется с учетом рабочей температуры);
CGD – емкость затвор-сток;
β – коэффициент усиления по току p-n-p транзистора;
RG_ext – выбранное значение сопротивление затворного резистора;
Rdriver_OFF – внутреннее сопротивление драйвера в состоянии OFF;
RG_int – паразитное сопротивление затвора.
Расчет статических и динамических потерь при коммутации MOSFET
Основные соотношения для расчета коммутационных потерь представлены в статье [Проблема выбора ключевых силовых транзисторов для преобразователей напряжения с жестким переключением. Александр Полищук. Силовая электроника №2, 2004 г.].
Статические потери
Мощность статических потерь для MOSFET транзисторов PVT_stat определяется выражением:

где:
Irms – среднеквадратичное значение тока через транзистор;
RDS – сопротивление сток-исток в открытом состоянии.
Динамические потери
Динамические потери MOSFET – транзисторов состоят из трех составляющих:
— энергия, выделяемая в кристалле при коммутации тока нагрузки I при рабочем напряжении V:

где:
I – ток нагрузки;
Vpow – напряжение питания;
tf – время спада напряжения на транзисторе (в момент коммутации);
tr – время нарастания напряжения на транзисторе (переход в закрытое состояние).
— энергия разряда выходной емкости транзистора, заряженной до напряжения питания:

где:
Vpow – напряжение питания;
Сoss – выходная емкость транзистора:

где:
СGD – ёмкость «затвор–сток»;
СDS – ёмкость «сток-исток».
— энергия, выделяемая при протекании реверсного тока восстановления паразитного диода:

где:
Qrr – заряд восстановления паразитного диода;
Vpow – напряжение питания.
Величина заряда восстановления паразитного диода транзистора Qrr приведена в datasheet для определенных режимов работы, как правило, соответствующих высоким скоростям изменения тока через транзистор и величинах тока, близких к максимальному). Таким образом, использование «даташитного» значения Qrr даст величину потерь близкую к очень наихудшему случаю. Для более точных расчетов целесообразно корректировать Qrrсогласно соотношению:

где:
Qrr_datasheet – значение заряда восстановления паразитного диода транзистора данная в datasheet;
IF_datasheet – значение прямого тока протекающего через паразитный диод транзистора при котором получено значение Qrr_datasheet ;
IF – значение прямого тока протекающего через паразитный диод транзистора в реальных условиях соответствующих расчету.
Общие динамические потери при переключении транзистора складываются из трех составляющих:


Переходя от суммарной энергии динамических потерь в каждом цикле к мощности потерь PVT_switch, получим выражение:

где:
f – частота коммутации.
I – ток нагрузки;
Vpow – напряжение питания;
tf – время спада напряжения на транзисторе (переход в открытое состояние);
tr – время нарастания напряжения на транзисторе (переход в закрытое состояние);
Qrr – заряд восстановления паразитного диода;
Сoss – выходная емкость транзистора:

здесь:
СGD – ёмкость «затвор–сток»;
СDS – ёмкость «сток-исток».
Расчет статических и динамических потерь при коммутации IGBT
Основные соотношения для расчета коммутационных потерь представлены в статье [Проблема выбора ключевых силовых транзисторов для преобразователей напряжения с жестким переключением. Александр Полищук. Силовая электроника №2, 2004 г.].
Статические потери
Для IGBT статические потери рассчитываются по соотношению:

где:
Iavg – среднее значение тока через транзистор;
VCE – напряжение насыщения перехода коллектор-эмиттер транзистора.
Соотношение справедливо при условии, что ток нагрузки на протяжении периода коммутации изменяется незначительно.
Динамические потери
Динамические потери IGBT – транзисторов состоят из трех составляющих:
— энергия, выделяемая в кристалле при переключении. Для IGBT-транзисторов, в отличие от MOSFET используется понятие энергии переключения Ets которая учитывает потери различного рода, в том числе потери, определяемые «хвостом» остаточного тока при выключении:

где:
Ets – суммарная энергия переключения;
— энергия разряда выходной емкости транзистора, заряженной до напряжения питания:

где:
Vpow – напряжение питания;
Сoes – выходная емкость транзистора:

где:
СGC – ёмкость «затвор–коллектор»;
СCE – ёмкость «коллектор-эмиттер».
— энергия, выделяемая при протекании реверсного тока восстановления специально введенного оппозитного диода (при наличии такового внутри IGBT):

где:
Qrr – заряд восстановления оппозитного диода;
Vpow – напряжение питания.
Величина заряда восстановления оппозитного диода IGBT-транзистора Qrr приведена в datasheet для определенных режимов работы, как правило, соответствующих высоким скоростям изменения тока через транзистор и величинах тока, близких к максимальному). Таким образом, использование «даташитного» значения Qrr даст величину потерь близкую к очень наихудшему случаю. Для более точных расчетов целесообразно корректировать Qrrсогласно соотношению:

где:
Qrr_datasheet – значение заряда восстановления оппозитного диода транзистора данная в datasheet;
IF_datasheet – значение прямого тока протекающего через оппозитный диод транзистора при котором получено значение Qrr_datasheet ;
IF – значение прямого тока протекающего через оппозитный диод транзистора в реальных условиях соответствующих расчету.
Общие динамические потери при переключении транзистора складываются из трех составляющих:


Переходя от суммарной энергии динамических потерь в каждом цикле к мощности потерь, получим выражение:

где:
f – частота коммутации;
Ets – суммарная энергия переключения;
Vpow – напряжение питания;
Qrr – заряд восстановления оппозитного диода;
Сoes – выходная емкость транзистора:

где:
СGC – ёмкость «затвор–коллектор»;
СCE – ёмкость «коллектор-эмиттер».
Драйверы класса «TrueDrive»
Как показано при описаниях процессов коммутации важно, чтобы драйвер MOSFET/IGBTтранзистора выдавал максимальный выходной ток при прохождении через «плато Миллера». Это существенно уменьшает динамические коммутационные потери на силовом ключе. В настоящее время существуют драйверы, выходной каскад которых обеспечивает высокий выходной и входной ток в районе «плато Миллера» — так называемые драйверы класса «TrueDrive». Их отличительной особенностью является использование в выходном каскаде как полевых, так и биполярных транзисторов. Структура такого драйвера представлена на рисунке DRV.10 на примере драйверов серий UCC27*** и UCC37***.
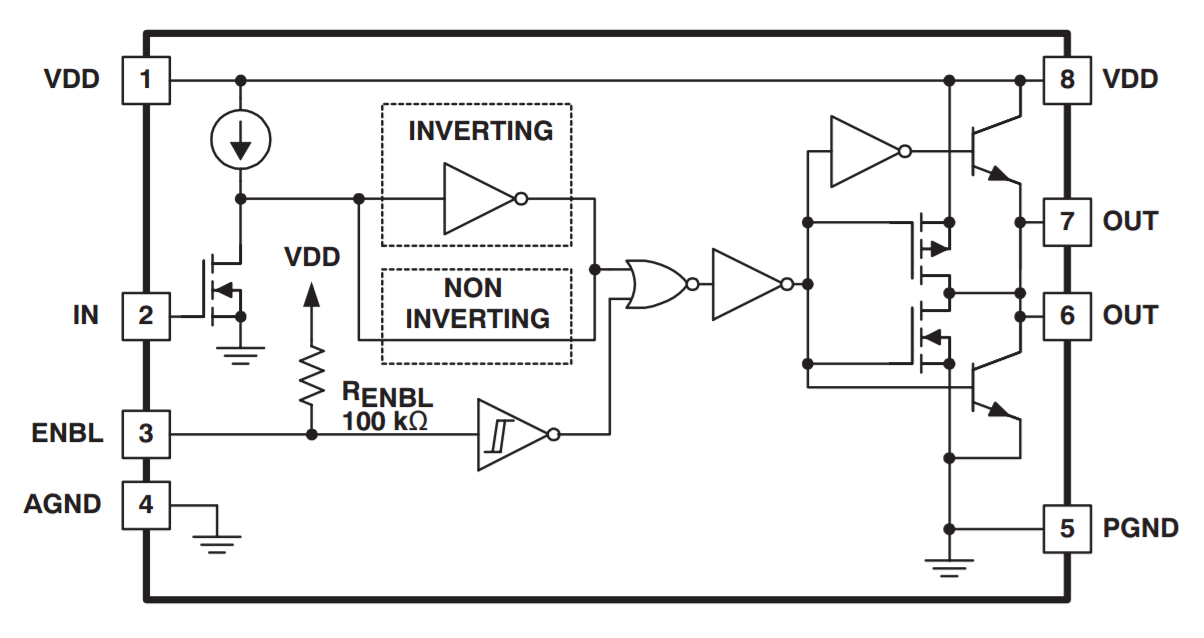
Рисунок DRV.10 — Структура драйвера типа «TrueDrive» [datasheet UCC27321 от Texas Instruments Incorporated]
Ряд типовых схемотехнических решений управления затвором
Ниже представлен ряд типовых схемотехнических решений управления затвором используемых при необходимости в тех или иных случаях.
Схема с затворным резистором
Стандартная схема управления с резистором в цепи затвора (рисунок DRV.11) – наиболее распространенное схемотехническое решение. Затворный резистор демпфирует возможные осцилляции в паразитном LC-контуре, и ограничивает скорость включения и выключения MOSFET-транзистора. Данная схема подходит в большинстве случаев для стандартных источников питания малой и средней мощности. Рекомендации по расчету величины сопротивления затворного резистора представлены выше.
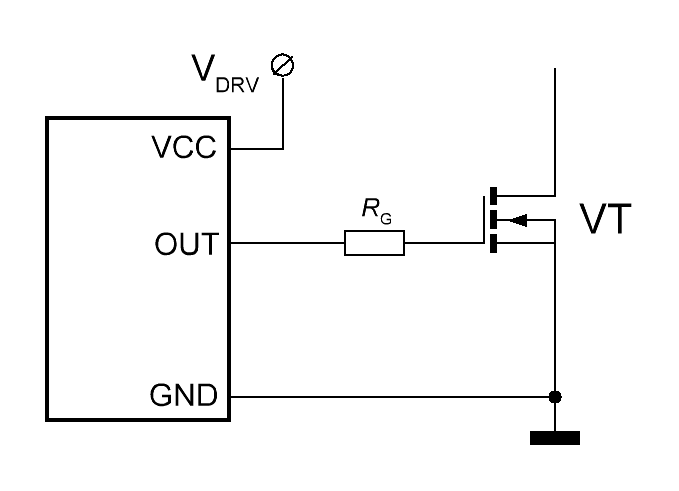
Рисунок DRV.11 — Стандартная схема управления с резистором в цепи затвора
Схема с обратным диодом в цепи затвора
Схема управления с обратным разрядным диодом в цепи затвора обеспечивает ускоренное выключение MOSFET-транзистора так как разряд емкости затвора происходит в обход затворного резистора «всей мощью тока драйвера». За счет этого сокращаются динамические потери на ключе. Это особенно актуально в тех случаях, когда необходимо замедлить процесс включения ключа (для ограничения максимальной dV/dt на другом ключе, или для уменьшения броска тока или для других целей) и одновременно минимизировать время его выключения. Кроме этого обратный диод повышает стойкость схемы к «паразитной коммутации» при высоких скоростях роста напряжения dV/dt на закрытом ключе. В качестве диода могут быть использованы быстродействующие маломощные кремниевые диоды типа 1N4148 (для токов до 1 А). Применение в схеме диодов Шоттки нежелательно по причине их большой емкости перехода по сравнению с кремниевыми диодами и возникающих вследствие этого осцилляций в паразитном LC контуре [Схемы управления затворами силовых транзисторов. А.М. Бобрешов, А.В. Дыбой, С.Ватхик, М.С. Куролап. ВЕСТНИК ВГУ. Серия: Физика. Математика. 2010. №2. с. 189-197]. Существует минимальное значение сопротивления затвора RG, при котором диод открывается:

где:
VVD – падение напряжения на паразитном диоде;
IG_max – пиковый ток затвора.
В остальном рекомендации по расчету величины сопротивления затворного резистора для данной схемы аналогичны рекомендациям для предыдущей схемы и представлены выше.
Недостатком схемы является значительная токовая нагрузка на драйвер на стадии выключения.
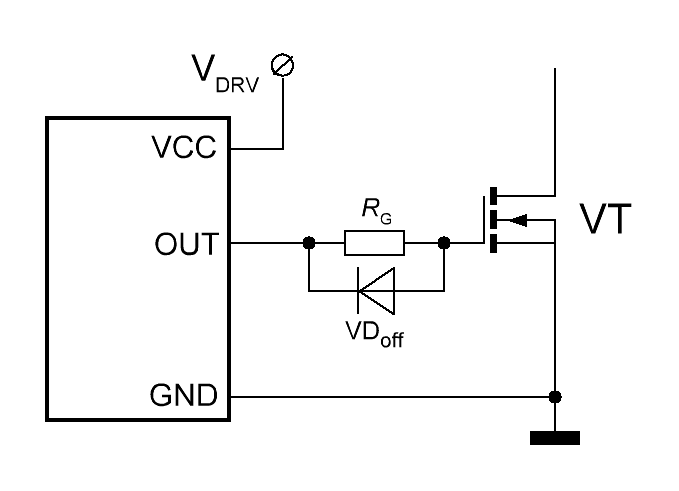
Рисунок DRV.12 Схема управления с обратным разрядным диодом в цепи затвора
Схема с независимо задаваемыми скоростями включения и выключения транзистора
Фактически представляет собой комбинацию предыдущих схем. Схема позволяет независимо задавать скорости включения и выключения MOSFET-транзистора. Рекомендации по расчету величины сопротивления затворного резистора для данной схемы аналогичны рекомендациям для предыдущей схемы.
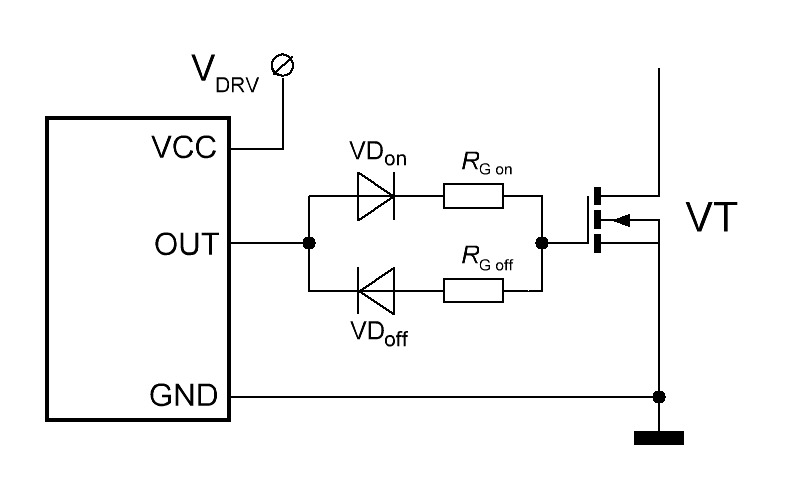
Рисунок DRV.13 — Схема управления с отдельно задаваемыми скоростями включения и выключения транзистора.
Схема управления с разрядным p-n-p транзистором
Данная схема обеспечивает ускоренный разряд емкости затвора, обеспечивает хорошую стойкость к высоким dV/dt. Маломощный p-n-p транзистор располагается в непосредственной близости к силовому MOSFET и обеспечивает короткий путь разряда емкости затвора в процессе выключения. Выбор транзистора осуществляется исходя из обеспечения высокого быстродействия и достаточного коэффициента усиления по току. Сопротивление резистора RGопределяет только скорость включения транзистора. Данное схемотехническое решение применяется в преобразователях средней и большой мощности. Преимуществом схемы является уменьшение нагрузки на выходной каскад драйвера (практически в два раза), поскольку разряд емкости затвора осуществляется через внешний транзистор.
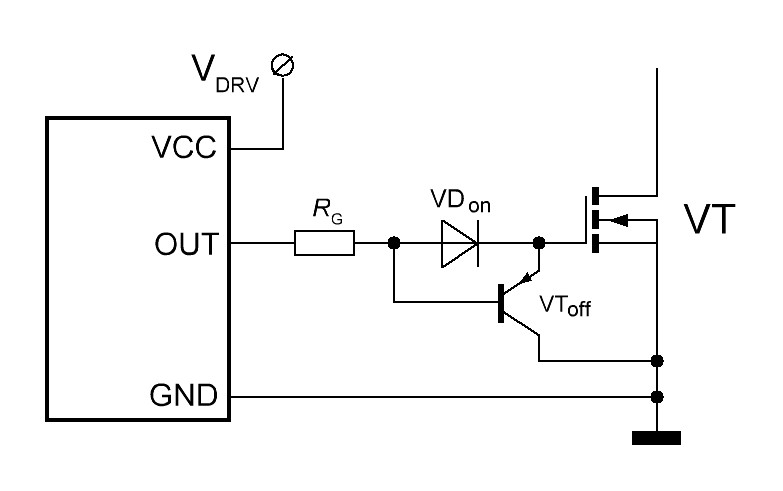
Рисунок DRV.14 — Схема управления с разрядным p-n-p транзистором
Схема с дополнительным разрядным MOSFET- транзистором
В схеме осуществляется быстрый разряд затвора силового MOSFET за счет маломощного MOSFET-транзистора. Среди недостатков данного решения следует отнести необходимость дополнительного инверсного выхода драйвера. Схема обладает высоким быстродействием.
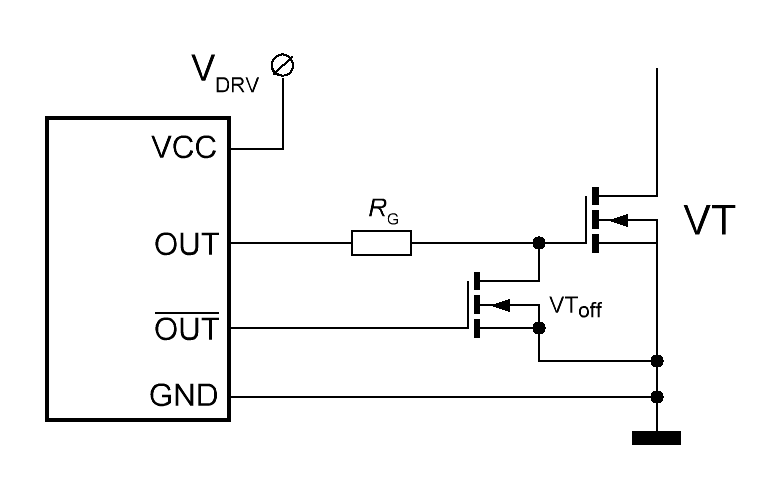
Рисунок DRV.15 — Схема управления с дополнительным разрядным MOSFET- транзистором
Схема с усилителем тока на комплементарных биполярных транзисторах
Схема управления с усилителем тока на комплементарных биполярных транзисторах (рисунок DRV.16) применяется при управлении «тяжелыми» затворами, когда выходного тока драйвера недостаточно для быстрого перезаряда емкости затвора.
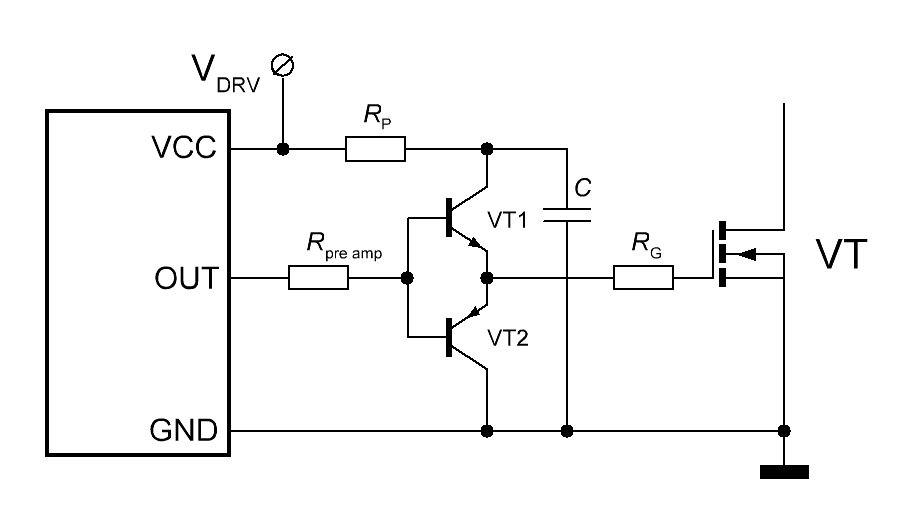
Рисунок DRV.16 — Схема управления с усилителем тока на комплементарных биполярных транзисторах
Схема с усилителем тока на MOSFET транзисторах
Схема управления с усилителем тока на MOSFET транзисторах (рисунок DRV.17) также используется при управлении «тяжелыми» затворами, когда выходного тока драйвера недостаточно для быстрого перезаряда емкости затвора. К отличительным особенностям схемы относятся инверсия сигнала управления, и несколько большее быстродействие.
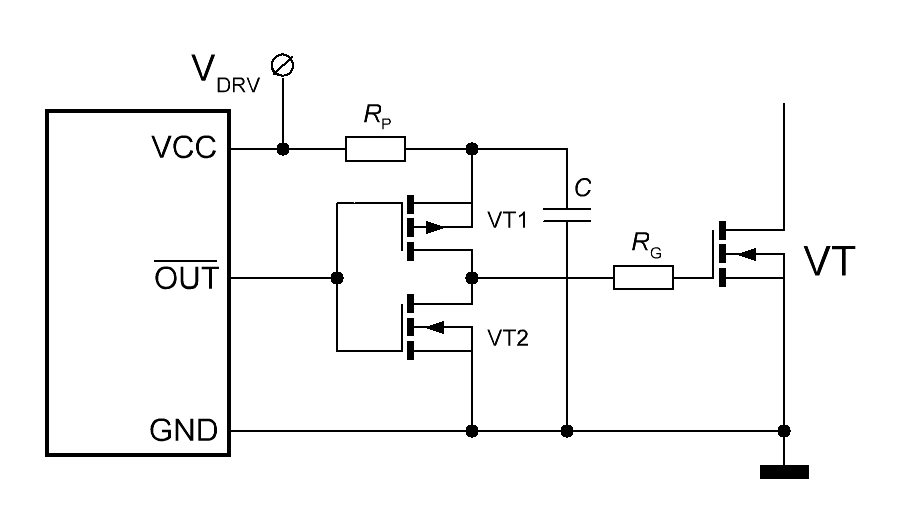
Рисунок DRV.17 Схема управления с усилителем тока на MOSFET транзисторах
Схема с усилителем тока на биполярных транзисторах c различными скоростями включения/выключения
Схема управления с усилителем тока на биполярных транзисторах c различными скоростями включения/выключения силового MOSFET транзистора используется в случае управления «тяжелыми» затворами при одновременном условии независимой установки скоростей включения и выключения транзистора.
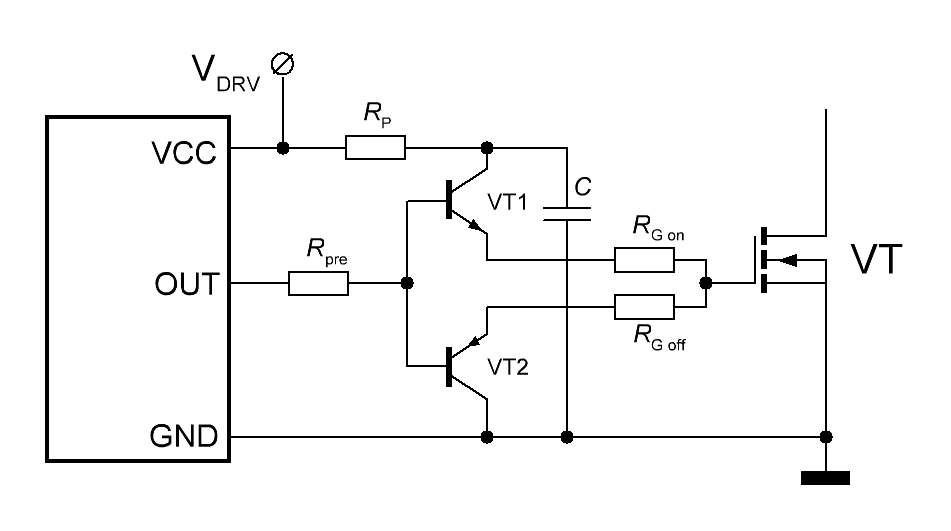
Рисунок DRV.18 — Схема управления с усилителем тока на биполярных транзисторах cразличными скоростями включения/выключения транзистора
Пробой затвора ключевого транзистора: причины и способы защиты
Причины пробоя затвора
Пробой затвора ключевого MOSFET- или IGBT транзистора может произойти вследствие ряда причин:
— превышение амплитуды управляющих импульсов напряжения пробоя затвора. Встречается редко, но вполне возможно, в случае если питание драйвера не стабилизировано.
— паразитная генерация в контуре «емкость затвора»-«индуктивность цепи управления» (так называемый «звон»). Причинами этого являются отсутствие или малая величина сопротивления затворных резисторов и слишком длинная цепь управления с большой паразитной индуктивностью и высокие скорости переключения.
— наводка в цепи управления за счет индуктивной (трансформаторной связи) между слишком длинной и широкой петлей управления и слишком близкорасположенным и слишком быстрым и сильноточным силовым контуром.
— слишком быстрый рост напряжения на стоке (коллекторе), вызывающий существенный ток через переходную емкость сток-затвор и рост напряжения на затворе.
— статическое электричество. Но это скорее при монтаже схемы.
— увеличение импеданса цепи управления.
Способы защиты от пробоя затвора
Существует несколько способов защиты от пробоя затвора (рисунок DRV.19):
— резистор в цепи «затвор-исток». Демпфирует колебания в цепи «драйвер-затвор» и снижает амплитуду колебаний. Менее эффективен, чем затворный резистор, но зато он практически не снижает разрядный зарядный ток. Устанавливается в непосредственной близости к транзистору. Основной целью введения резистора в управляющие схемы является предотвращение избыточного «перезаряда» входной емкости затвора при увеличении импеданса цепи управления [Подключение сигнальных цепей в мощных преобразовательных устройствах. Андрей Колпаков. Новости электроники №15. 2008. Статья 9].
— суппресор TVS в цепи «затвор-исток». Существенно более эффективная, но дорогая защита. Суппресор также ставится в непосредственной близости от транзистора.
— диод Шоттки, установленный между затвором и цепью питания.
— комбинированная защита, включающая суппресор TVS и резистор для предотвращения избыточного «перезаряда» емкости затвора.
— маломощный MOSFET-транзистор, включающийся при превышении затворного напряжения определенного уровня, задаваемого резисторным делителем R1/R2. Эта схема предназначена больше для мощных IGBT-транзисторов.

Рисунок DRV.19 — Реализация защиты от перенапряжения на затворе MOSFET и IGBT — транзисторов
Защита от пробоя затвора актуальна в случае, если драйвер и силовой ключ разнесены на значительное расстояние. Это является причиной возникновения наводок и паразитных осцилляций. В этих случаях может быть целесообразно использование транзисторов с повышенным максимальным напряжением затвор-исток (например ±30В вместо ±20В).
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 1 | |
Высокое напряжение и линейный режим08.05.2017, 19:37. Показов 5017. Ответов 13
Всем привет. Стоит задача рассеять сотню ватт при высоком напряжении, из транзисторных запасов подошли только IGBT BUP213 и BUP314. Вот их области безопасной работы: <Изображение удалено> По сочетанию тока и напряжения укладываемся в границы графика для постоянки, хорошо, для доп. облегчения задачи будут два транзистора параллельно, чтобы лучше размазать тепло по радиатору. Транзисторы изъяты из довольно старого девайса, да и даташиты на них датированы, страшно подумать — 1995 и 1996 годами соответствено. В доках на более современные транзы, например, IRG4PC40UD и IRFP4232, графика DC нет вообще. <Изображение удалено> Понятно, что спецтранзы для линейного режима надо юзать, но какой русский не любит ваять из уже имеющегося говна? xD Вопрос — где у более современных приборов предел на постоянке? __________________
0 |
| 0 / 0 / 0 Регистрация: 07.02.2106 Сообщений: 3,113 | |
| 08.05.2017, 21:40 | 2 |
| Гм. Вы в курсе, что транзисторы можно соединять последовательно? https://www.cyberforum.ru/savedimages/2017/05/08/qtkmrc8bnctszvvpzgqxw.gif Кстати, мысль о древних транзисторах очень верная. Современные транзисторы, как и старые _перевыпущенные_(!!!!), имеют очень отвратную SOO по DC. Причина — «тупо» кристалл стал меньше. В старых не умели так хорошо упаковывать переходы, кристаллы были больше. Например, новый IRFP250 при мощности 250 Вт (кажись) может отдать по DC не более 40 Вт. Причем, это реальный предел, а не документация. Старый IRFP250 легко отдавал гораздо больше. (я гонял 200 Вт)
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 09.05.2017, 09:09 | 3 |
| Картинки нет. Да, знаю, в старину так и делали, в аналогичном девайсе, откуда я взял BUPы, но нашего производства, стояли два 2SC3451 последовательно, ибо 500 вольт было мало. Это существенно усложнает рулежку ими, нет? Есть способ обойтись малой кровью — мощный резистор перед транзистором, чтоб на нем при работе падало напряжение и транзу было попроще, 25-50% мощности думаю можно отдать резистору. Да, оптимизация под ключевой режим не идет на пользу линейному, мягко говоря. Вспоминаем тренч-мосфеты, они в линейном режиме никакие. Ага, спасибо за инфу. Какие напряжения и токи у вас были при 200 и 40 ваттах?
0 |
| 0 / 0 / 0 Регистрация: 07.02.2106 Сообщений: 3,113 | |
| 09.05.2017, 12:39 | 4 |
| Верхние транзисторы «пассивные», они сами регулируют себя. Ничего делать не надо. А т.к. сопротивление нагрузки достаточно низкоомное, то делители в базе (затворе) верхних транзисторов могут быть достаточно низкоомными. (фактически, делитель является параллельным шунтом, а потому полезен — на нем тоже рассеивается мощность). Картинки нет? тогда так — http://un7bv.narod.ru/oe-oe-ob.htm — 2 картинка и далее. В MOSFET главная беда — открыть ВСЕ ячейки. В линейном режиме открывается только небольшая часть ячеек и транзистор сгорает от локального перегрева. Для этого надо перевести транзистор в режим насыщения, или близкий к нему. Это означает использование транзистора на почти предельном токе и низком напряжении. Про IGBT теоретизировать не буду, практически не использовал. Одно лишь хочу напомнить — на входе у него все тот-же MOSFET, а pnp за ним только усилитель тока. Думаю, правила те-же. Мне надо было тестировать СО процессора, поэтому нужен был компактный нагреватель. В его качестве я и поставил MOSFET. IRFP250 выдержал часовые нагрузки на 250 W без проблем (10А), а BUZ11 (TO220) на своей мощности уже был с проблемами. Вначале я дал (его) максимальный ток и низкое напряжение — он не выдержал. Затем поставил 1/2 максимального тока и поднял напряжение — тесты удалось провести нормально. Думаю, моя ошибка была в том, что to220 плохо отводит тепло, а MOSFET не любит большого тока на большой температуре. Т.е. банально не учел снижения Imax от нагрева. Впрочем, это было довольно давно. Сейчас бы я поставил Imax(100C)/2. Не меньше и не больше. IMHO естественно.
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 09.05.2017, 16:28 | 5 |
| Хм, а ведь действительно, верхний транзистор может болтаться там самостоятельно, проводить у него не выйдет, пока нижний закрыт, только нижний вывод R4 надо к эмиттеру наверно. Но если так сделать, нижний получит на коллектор все питание, хоть и с ограничением по току, и может пробиться. А если не сделать, с питания на землю потечет через те два резистора… Да, меньше ячеек задействовано — меньше ток можно пускать. Если рассеиваемая мощность невелика, тепло по кристаллу будет успевать расползаться, но малая мощность это не интересно, мы не затем ставим ТО-247 чтоб пару ватт рассеять. Печально. Насчет IGBT, вот два 40UD, расколупанных сегодня: <Изображение удалено> Думаю, все норм будет. В любом случае, я сюда отпишу как будет что написать.
0 |
| 0 / 0 / 0 Регистрация: 07.02.2106 Сообщений: 3,113 | |
| 09.05.2017, 16:30 | 6 |
| Второй девайс в корпусе — это обратный диод.
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 26.05.2017, 14:19 | 7 |
| https://www.microsemi.som/document-port … t-tutorial Сей документ говорит, что IGBT это почти MOSFET. Седовательно, от него можне ждать похожего поведения. <Изображение удалено> Здесь же — http://www.kerrywong.som/2016/10/08/lin … onic-tood/ говорится, что ключевой MOSFET IRFP150N дох при выделении 45-60 ватт в линейном режиме. Линейный же транзистор IXTK90N25L2 рассеивал 250 ватт в одиночку и не морщился. Так же он способен брать 55 ампер при 3,3 вольтах. Так что если нет в наличии охапки бесплатных ключевых транзов — имеет смысл потратиться на один такой, в итоге схема будет проще, а девайс надежнее. Хотя вот тут — http://bsvi.ru/aktivnaya-nagruzka/ товарищ BSVi рассеивал 100 ватт на аналоге IRFP460, который ни разу не для линейного режима.
0 |
| 0 / 0 / 0 Регистрация: 07.02.2106 Сообщений: 3,113 | |
| 26.05.2017, 14:45 | 8 |
| «Здесь же — http://www.kerrywong.som/2016/10/08/lin … onic-tood/ говорится, что ключевой MOSFET IRFP150N дох при выделении 45-60 ватт в линейном режиме. « <Изображение удалено> Под 63В надо ставить что-то типа IRFP460 (400-600В).
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 26.05.2017, 15:08 | 9 |
| Так 200 ватт на 6 транзов это 33 ватта на каждый. Что заметно менее чем «45-60», вот и работало.
0 |
| 0 / 0 / 0 Регистрация: 07.02.2106 Сообщений: 3,113 | |
| 26.05.2017, 15:15 | 10 |
| Ага. Кроме того, парные транзисторы работали без выравнивания тока между ними. Т.е. фактически — там было всего 3 транзистора.
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 26.05.2017, 15:23 | 11 |
| Теоретически один из каждой пары мог сдохнуть от хот-спота или разбаланса токов, и второй в паре бы сдох следом. Но этого не произошло.
0 |
| 0 / 0 / 0 Регистрация: 07.02.2106 Сообщений: 3,113 | |
| 26.05.2017, 20:50 | 12 |
| Могу высказать личное мнение, и оно может быть ошибочным. Подтверждений/опровержений специально не искал (лень). Повторяю — просто личные наблюдения, могу ошибаться. ))
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 26.05.2017, 22:14 | 13 |
| Ну какие они старые?)) IXTxxxxxxx до сих пор производятся и продаются)) Не всем же нужны только ключевые транзы.
0 |
| 0 / 0 / 0 Регистрация: 23.01.2010 Сообщений: 2,550 | |
| 28.05.2017, 08:49 | 14 |
| Нашел на работе кучку IGBT FGA20N120, даташит 2013 года удивил наличием SOO для DC. Несмотря на Trench в названии, он способен держать один ампер при сотне вольт на коллекторе, что весьма недурно. <Изображение удалено>
0 |
М. Хермвиль, А. Колпаков
Новости Электроники 13, 2008
В предыдущей статье [1] мы рассмотрели процессы, происходящие в затворе IGBT при его коммутации, и определили мощность, необходимую драйверу для работы. В предлагаемом материале продолжается обсуждение вопросов, связанных с управлением силовыми ключами с изолированным затвором. Поведение IGBT в режиме переключения определяется характеристиками цепей, осуществляющих перезаряд входных емкостей. В первую очередь к ним относятся выходной каскад драйвера и резистор затвора RG (описаны в [2]…[6]).


Включение IGBT производится подачей на затвор положительного напряжения (как правило, VG(on) = +15 B), типовое значение напряжения выключения находится в диапазоне VG(off) = -5…-15 В. При определенных величинах VG(on)/VG(off) динамические характеристики ключа могут быть заданы резисторами, установленными в цепи затвора и ограничивающими его ток IG (см. рис. 1, 2).
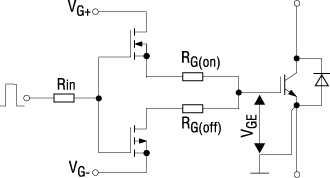
Рис. 1. Цепь управления затвором
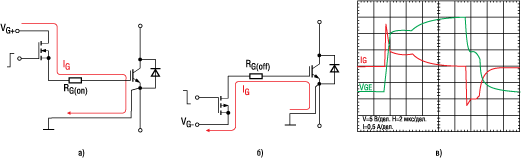
Рис. 2. А, Б — ограничение тока включения/выключения с помощью резисторов RG(on), RG(off), В — напряжение VGE и ток затвора IG
С помощью подбора номиналов RG(on)/RG(off) можно изменить время переключения, уровень динамических потерь и коммутационных перенапряжений, а также ряд других параметров, включая состав спектра электромагнитных помех. Таким образом, выбор импеданса цепи управления затвором — один из важнейших этапов проектирования, требующий самого пристального внимания.
Величины емкостей затвора зависят от напряжения «коллектор — эмиттер» VCE IGBT, поэтому они изменяются в процессе его коммутации. Соответствующие графики зависимости Cies, Coes, Cres от VCE приводятся в технических характеристиках силовых модулей. Импеданс цепи управления, ограничивающий пиковое значение тока затвора IG в моменты включения и выключения, определяет время перезаряда входных емкостей. На рисунке 2а и 2б показаны цепи протекания токов при использовании раздельных резисторов линий включения и выключения RG(on)/RG(off), форма тока затвора IG при подаче импульса управления VGE приведена на рисунке 2в.
При уменьшении значений RG(on)/RG(off) снижается постоянная времени цепи перезаряда, соответственно уменьшается время переключения tR/tF и уровень динамических потерь ESW. Несмотря на положительный эффект от снижения рассеиваемой мощности, увеличение скорости спада тока ведет к опасному росту уровня коммутационных перенапряжений Vstray, вызванных наличием распределенной индуктивности LS силовых шин звена постоянного тока: Vstray = LS × di/dt.
Наглядное представление о данном эффекте дают эпюры, приведенные на рисунке 3.
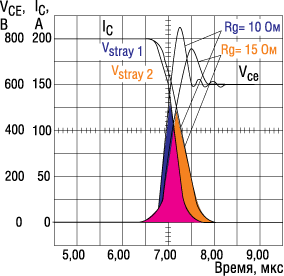
Рис. 3. Рост коммутационного перенапряжения Vstray при увеличении di/dt
Затемненная область графиков, являющаяся произведением тока коллектора IC на напряжение VCE в течение времени выключения, представляет собой энергию потерь Eoff.
При неудачной конструкции DC-шины и большом значении LS всплеск напряжения Vstray способен вывести силовой ключ из строя. Особенно опасным процесс становится в режиме отключения IGBT при коротком замыкании (КЗ), когда величина di/dt максимальна. Уровень Vstray может быть снижен за счет выбора большего номинала резистора RGoff (15 Ом вместо 10 Ом, как показано на рисунке). Именно поэтому в некоторых драйверах IGBT (например, SKYPER 32PRO) реализован режим плавного отключения SSD (Soft Shut Down), при котором запирание IGBT осуществляется через отдельный резистор RG(off) большого номинала. Естественной платой за это является увеличение энергии потерь, поэтому при использовании современных типов IGBT и корректной топологии DC-шины применение режима SSD не рекомендуется.
Следует также отметить, что увеличение скоростей переключения, приводящее к росту di/dt и dv/dt, повышает и уровень излучаемых преобразователем электромагнитных помех (EMI). В таблице 1 показано, как изменение величины резистора затвора влияет на основные динамические характеристики IGBT.
Таблица 1. Влияние резистора затвора на динамические свойства IGBT
| Динамические характеристики | RG | RG¯ |
|---|---|---|
| Время включения, ton | ← | ↓ |
| Время выключения, toff | ← | ↓ |
| Энергия включения, Еon | ← | ↓ |
| Энергия выключения, Еoff | ← | ↓ |
| Пиковый ток включения (IGBT) | ↓ | ← |
| Пиковый ток выключения (диод) | ↓ | ← |
| Скорость изменения напряжения, dv/dt | ↓ | ← |
| Скорость изменения тока, di/dt | ↓ | ← |
| Уровень перенапряжения при коммутации, Vstray | ↓ | ← |
| Уровень электромагнитных помех (EMI) | ↓ | ← |
Недавно компания SEMIKRON выпустила на рынок четвертое поколение модулей на базе кристаллов IGBT Trench 4 и быстрых диодов CAL 4 [7]. Одним из основных достоинств новых модулей является пониженная почти на 30% скорость изменения тока di/dt при меньшем (примерно на 20%) значении энергии потерь. Благодаря этому применение новых ключей позволяет не только повысить эффективность преобразования, но и улучшить электромагнитную совместимость и снизить риск пробоя в аварийных ситуациях.
Динамические характеристики оппозитного диода IGBT также зависят от номинала резистора затвора и во многом определяют его минимальное значение. Скорость включения транзистора не должна превышать скорости обратного восстановления диода: снижение величины RG и соответствующее увеличение diC/dt приводит не только к росту уровня перенапряжения при запирании IGBT, но и создает динамический стресс для диода.
В своих модулях компания SEMIKRON использует быстрые диоды, производимые по собственной технологии CAL (Controlled Axial Lifetime), позволяющей изменять время жизни носителей. Их основным отличием является плавная характеристика обратного восстановления dirr/dt и оптимально согласованные с IGBT динамические характеристики. Это способствует снижению уровня динамических потерь и EMI, а также уменьшению величины перенапряжений при выключении.
Выбор резистора затвора
Как правило, выходной каскад драйверов строится по двутактной схеме с разделенным выходом, как показано на рисунке 1. Входы обоих MOSFET-транзисторов управляются одним логическим сигналом: когда он имеет высокий уровень, открывается N-канальный ключ, при низком уровне — Р-канальный. Использование разделенного выхода позволяет формировать асимметричное напряжение управления VGE и подбирать номиналы резисторов RG независимо для режимов включения и выключения.
Оптимизация цепи управления затвором подразумевает выбор номиналов RG(on)/RG(off) (при заданном значении VGE), обеспечивающий минимальный уровень динамических потерь, отсутствие опасных осцилляций при переключении, малый ток обратного восстановления оппозитного диода и низкий уровень коммутационных перенапряжений. Поиск оптимума затруднен тем, что часть указанных параметров находится в противоречии друг с другом (см. таблицу 1).
Как правило, для управления более мощным IGBT требуется меньший резистор затвора и наоборот. При этом значение RG, указанное в качестве референсного (RGref) в технических характеристиках, не всегда обеспечивает наилучший баланс указанных выше свойств. Оптимальная величина резистора для большинства конкретных применений находится в диапазоне RGref…2 × RGref. Как правило, величина RGref является и минимально рекомендуемой, обеспечивающей безопасное отключение предельно допустимого импульсного тока IGBT (ICM). Напомним, что область безопасной работы (ОБР или SOA) нормируется для ICM или двойного номинального тока коллектора ICM = 2 × IC.
В большинстве практических схем именно сопротивление 2 × RGref обеспечивает необходимый баланс и с него начинается процесс оптимизации динамических характеристик. Уменьшение номинала резистора затвора возможно только до тех пор, пока растущая скорость коммутации тока di/dt не вызывает появления опасных перенапряжений. Следует также помнить о том, что снижение импеданса цепи управления затвором приводит к повышению токовой нагрузки на драйвер и увеличению рассеиваемой им мощности.
Правильность выбора RG при проектировании должна подтверждаться испытаниями готовой конструкции, включающими анализ тепловых режимов и измерение величины Vstray при всех условиях эксплуатации вплоть до короткого замыкания. Именно такая методика используется дизайнерским центром SEMIKRON во Франции, разработавшим за 35 лет более 12000 проектов различных устройств, мощностью от десятков кВт до единиц МВт.
Практические рекомендации
При выборе сопротивления затвора следует учитывать, что во время протекания токов заряда/разряда на нем может рассеиваться большая мощность. Рекомендуется выбирать резисторы, имеющие низкий температурный коэффициент ТКС и разброс номиналов, не превышающий 1%. В большинстве случаев хорошим решением является использование параллельного соединения некоторого количества сопротивлений в smd- исполнении (MELF, MINI-MELF). При этом обеспечивается высокая стойкость к импульсным перегрузкам, хорошее распределение тепла и нечувствительность схемы к отказу одного из сопротивлений.
Ошибка в выборе RG может привести к крайне нежелательным последствиям, при этом необходимо анализировать влияние цепи управления затвором на все режимы работы преобразователя. Например, увеличение номинала RG, позволяющее снизить уровень коммутационных выбросов, неизбежно приведет к росту динамических потерь и перегреву силового ключа. Возможным следствием использования неоправданно большого резистора затвора может быть переход IGBT в линейный режим и появление осцилляций в затворной цепи. В свою очередь, как уже было отмечено, результатом применения слишком малого RG является рост всплесков напряжения при переключении и повышение уровня EMI.
Разработчик должен отдавать себе отчет в том, что оптимизация цепи управления затвором не может компенсировать негативные последствия, вызванные неудачной конструкций DC-шины, не обеспечивающей низкое значение распределенной индуктивности LS. В этом случае уровень коммутационных перенапряжений может быть опасным даже в номинальных режимах эксплуатации, поэтому минимизация величины LS является первой и главной задачей разработки звена постоянного тока. Только в случае решения данной проблемы можно думать об оптимизации RG и целесообразности применении режима плавного отключения SSD.
Резисторы затвора должны располагаться максимально близко к выводам управления модуля IGBT, соединение выходов драйвера с ними должно по возможности производиться прямым бифилярным проводом. В противном случае в паразитном контуре, образованном распределенной индуктивностью линии Lwire и входной емкостью IGBT Cies могут возбуждаться опасные колебания. Одним из способов борьбы с ними является также выбор резистора затвора на основе соотношения RG(min) ≥ 2 × (Lwire/Cies)1/2.
Литература
- Маркус Хермвиль, Андрей Колпаков, «Управление изолированным затвором IGBT. Основные положения, часть 1», Новости Электроники №11, 2008
- Application Manual Power Modules, Semikron International
- M. Hermwille, «Gate Resistor — Principles and Applications», Application Note AN-7003, Semikron International
- M. Hermwille, «Plug and Play IGBT Driver Cores for Converters», Power Electronics Europe Issue 2, pp. 10-12, 2006
- P. Bhosale, M. Hermwille, «Connection of Gate Drivers to IGBT and Controller», Application Note AN-7002, Semikron International
- M. Hermwille, «IGBT Driver Calculation», Application Note AN-7004, Semikron International
- Андрей Колпаков, «Trench 4. Инструкция по эксплуатации», Силовая Электроника №2, 2008.
Когда ключ закрыт, на слой n подается напряжение. Когда управляющее напряжение подается на изолированный затвор, область p формирует открытый канал, включая полевой транзистор, который, в свою очередь, открывает биполярный p-n-p элемент. Ток начинает протекать между внешним коллектором и эмиттером. В то же время ток стока ячейки возбуждения усиливается. Когда биполярный элемент открыт, остаточное напряжение в n-области еще больше падает из-за потока электронов и дырок.
Полупроводниковый переключатель является одним из наиболее важных компонентов в силовой электронике. Они составляют основу практически всех бестрансформаторных преобразователей тока и напряжения, инверторов и частотных преобразователей.
Полупроводниковый переключатель является одним из наиболее важных компонентов в силовой электронике. Они являются основой практически всех бестрансформаторных преобразователей тока и напряжения, инверторов и частотных преобразователей.

Использование электронных переключателей позволяет упростить схему преобразователя, значительно уменьшить размеры устройств и улучшить технические параметры.
Основные свойства полупроводниковых переключателей:
- Управление током или напряжением.
- Номинальное напряжение и ток канала питания.
- Сопротивление канала.
- Допустимая частота переключения.
- Статические и динамические потери.
В преобразовательных системах используются двухсторонние тиристоры с управляющими электродами (GTO и IGCT), силовые биполярные транзисторы (BP) и полевые транзисторы (MOSFET), биполярные транзисторы с изолированным затвором (IGBT).
Первые силовые электронные устройства были основаны на тиристорах и биполярных транзисторах. Первые, при всех их преимуществах, не могут обеспечить необходимую скорость реакции, управляемые тиристоры используются в среднечастотном диапазоне.
Применение биполярных транзисторов существенно ограничено низким коэффициентом передачи тока, значительным температурным изменением этого параметра, управлением переменным напряжением и низкой плотностью тока в цепи питания.
Схемы с биполярными транзисторами должны включать дополнительные схемы для обеспечения контроля и защиты полупроводниковых компонентов. Это значительно повышает стоимость преобразователей и усложняет их производство.
Основными полупроводниковыми элементами, используемыми в настоящее время в силовой электронике, являются полевые транзисторы (MOSFETs), биполярные транзисторы с изолированным затвором (IGBTs).
MOSFET в основном используются в высокочастотных низковольтных преобразователях, IGBT – в мощных высоковольтных цепях.
Общая схема переключения довольно сложна, поскольку изменяется подвижность носителей заряда, коэффициенты передачи тока p-n-p и n-p-n транзисторов, присутствующих в структуре, изменяются сопротивления областей и т.д. Хотя в принципе IGBT могут использоваться в линейном режиме, они все же чаще всего применяются в режиме переключения.
IGBT транзисторы
 Биполярные транзисторы с изолированным затвором – это новый тип активных приборов, появившийся сравнительно недавно. Их входные характеристики похожи на полевые транзисторы, а выходные – на биполярные транзисторы.
Биполярные транзисторы с изолированным затвором – это новый тип активных приборов, появившийся сравнительно недавно. Их входные характеристики похожи на полевые транзисторы, а выходные – на биполярные транзисторы.
В литературе это устройство называют IGBT (биполярный транзистор с изолированным затвором). По скорости работы они значительно превосходят биполярные транзисторы. IGBT чаще всего используются в качестве мощных переключателей с временем включения 0,2-0,4 мкс и временем выключения 0,2-1,5 мкс, напряжением коммутации до 3,5 кВ и током до 1200 А.
 IGBT заменяют тиристоры в высоковольтных системах преобразования частоты и позволяют создавать импульсные вторичные источники питания с качественно лучшими характеристиками. IGBT достаточно широко используются в инверторах управления двигателями и в системах аварийного питания при высоких нагрузках, с напряжением более 1 кВ и токами в сотни ампер. Это в определенной степени является следствием того, что в включенном состоянии при токах порядка сотен ампер падение напряжения на транзисторе находится в диапазоне от 1,5 В до 3,5 В.
IGBT заменяют тиристоры в высоковольтных системах преобразования частоты и позволяют создавать импульсные вторичные источники питания с качественно лучшими характеристиками. IGBT достаточно широко используются в инверторах управления двигателями и в системах аварийного питания при высоких нагрузках, с напряжением более 1 кВ и токами в сотни ампер. Это в определенной степени является следствием того, что в включенном состоянии при токах порядка сотен ампер падение напряжения на транзисторе находится в диапазоне от 1,5 В до 3,5 В.
Как видно из конструкции транзистора IGBT (рис. 1), это довольно сложное устройство, в котором p-n-р транзистор управляется n-канальным МОП-транзистором.

Коллектор IGBT-транзистора (рис. 2,a) является эмиттером транзистора VT4. При подаче положительного напряжения на затвор транзистора VT1 образуется электропроводящий канал. Через этот канал эмиттер IGBT (коллектор транзистора VT4) соединен с базой транзистора VT4.
В результате он полностью открывается, и падение напряжения между коллектором IGBT и его эмиттером становится равным эмиттерному переходу VT4, суммируется с падением напряжения Uci на VT1.
Поскольку падение напряжения на p-n-переходе уменьшается с ростом температуры, падение напряжения на открытом IGBT в определенном диапазоне токов имеет отрицательный температурный коэффициент, который становится положительным при больших токах. Поэтому падение напряжения на транзисторе IGBT не опускается ниже порогового напряжения диода (эмиттерный переход VT4).
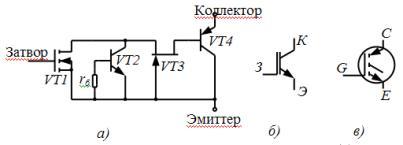
Рисунок 2. Эквивалентная схема IGBT транзистора (а) и его обозначение в отечественной (б) и зарубежной литературе (в)
По мере увеличения напряжения, подаваемого на IGBT-транзистор, ток канала, определяющий ток базы транзистора VT4, увеличивается, а падение напряжения на IGBT-транзисторе уменьшается.
 Когда транзистор VT1 заперт, ток транзистора VT4 становится небольшим, что позволяет считать его запертым. Дополнительные слои вводятся для устранения режимов работы, характерных для тиристоров при лавинном пробое. Буферный слой с n+ и широкая базовая область с n- обеспечивают пониженный коэффициент усиления по току для p-n-p транзистора.
Когда транзистор VT1 заперт, ток транзистора VT4 становится небольшим, что позволяет считать его запертым. Дополнительные слои вводятся для устранения режимов работы, характерных для тиристоров при лавинном пробое. Буферный слой с n+ и широкая базовая область с n- обеспечивают пониженный коэффициент усиления по току для p-n-p транзистора.
Общая схема включения и выключения довольно сложна, поскольку изменяется подвижность носителей заряда, коэффициенты передачи тока p-n-p и n-p-n транзисторов, присутствующих в структуре, изменяется сопротивление области и т.д. Хотя в принципе IGBT могут использоваться для линейной работы, до сих пор они применялись в основном в ключевом режиме.
В этом случае изменения напряжения на коммутируемом переключателе характеризуются кривыми, показанными на рисунке 3.
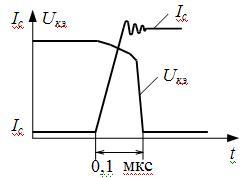

Рисунок 4: Эквивалентная схема IGBT транзистора (a) и его вольт-амперная характеристика (b)
Испытания показали, что время включения и выключения большинства IGBT не превышает 0,5-1,0 мкс. Чтобы уменьшить количество дополнительных внешних компонентов, IGBT-транзисторы комплектуются диодами или модулями, состоящими из нескольких компонентов (рис. 5, a-d).
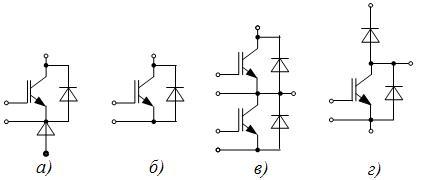
Рисунок 5: IGBT-транзисторные модули: a – MTKID; b – MTKI; c – M2TKI; d – MDTKI
Обозначения IGBT включают: буква М – беспотенциальный модуль (изолированная база); 2 – количество ключей; буквы ТКИ – биполярный с изолированным затвором; ДТКИ – диод/биполярный транзистор с изолированным затвором; ТКИД – биполярный транзистор с изолированным затвором/диодом; цифры: 25, 35, 50, 75, 80, 110, 150 – максимальный ток; числа: 1, 2, 5, 6, 10, 12 – максимальное напряжение между коллектором и эмиттером Uкэ (*100В). Например, модуль МТКИД-75-17 имеет Uкэ =1700 В, I=2*75А, Uкэ =3,5 В, PKmax =625 Вт.
Профессор Л.А.Потапов, д.ф.н.
Если вам понравилась эта статья, пожалуйста, поделитесь ссылкой на нее в социальных сетях. Это очень поможет в развитии нашего сайта!
Диапазон применения – токи от нескольких десятков А до 1200 А, напряжения от нескольких сотен вольт до 10 кВ. В диапазоне токов до десятков А и напряжений до 500 В вместо IGBT следует использовать обычные MOSFET, поскольку полевые транзисторы имеют более низкий импеданс при низких напряжениях.
Приложения


Основными областями применения IGBT являются инверторы, импульсные регуляторы тока и частотно-регулируемые приводы.
IGBT широко используются в источниках сварочного тока, в приложениях с высоковольтным приводом, включая городской электротранспорт.
Использование IGBT-модулей в системах управления тяговыми двигателями позволяет (по сравнению с тиристорами) добиться высокого КПД, высокой плавности работы машины и возможности рекуперативного торможения практически на любой скорости.
IGBT используются при высоких напряжениях (более 1000 В), высоких температурах (более 100°C) и высокой выходной мощности (более 5 кВт). IGBT используются в схемах управления двигателями (на рабочих частотах ниже 20 кГц), источниках бесперебойного питания (постоянная нагрузка и низкая частота) и сварочных аппаратах (где требуется большой ток и низкая частота до 50 кГц).
IGBT и MOSFET занимают диапазон средней мощности и частоты, с некоторым “перекрытием”. В целом, MOSFET наиболее подходят для высокочастотных и низковольтных каскадов, а IGBT – для мощных каскадов.
В некоторых случаях IGBT и MOSFET полностью взаимозаменяемы, а назначение выводов и характеристики управляющих сигналов у обоих устройств обычно одинаковы. IGBT и MOSFET требуют 12-15 В для полного включения и не нуждаются в отрицательном напряжении для выключения. Но “управляемый напряжением” не означает, что схема управления не нуждается в источнике тока. Драйвер затвора IGBT или MOSFET для схемы управления представляет собой конденсатор с величиной емкости до тысяч пикофарад (для мощных устройств). Драйвер затвора должен “знать”, как быстро заряжать и разряжать эту емкость, чтобы гарантировать быстрое переключение транзистора.
IGBT-транзисторы делятся на четыре группы в зависимости от скорости переключения, как показано в таблице IGBT.1 :
Модуль Igbt что это такое
IGBT-транзистор является гибридным устройством
IGBT (Insulated-Gate Bipolar Transistor) – это полупроводниковый прибор для переключения мощности, представляющий собой интегрированную структуру, состоящую из входного полевого транзистора и силового биполярного транзистора. Они используются в 99,999% приложений в качестве ключевых устройств. По своим электрическим свойствам они представляют собой “грейпфрут” полевого транзистора с изолированным затвором и биполярного транзистора. IGBT управляются напряжением, как полевые транзисторы; когда они включены, они имеют некоторое напряжение насыщения коллектор-эмиттер; относительно медленное выключение (“токовый хвост” как наследие биполярных транзисторов). Подробности о внутренней структуре IGBT-транзисторов можно найти в [Энциклопедия полевых транзисторов. Дьяконов В.П. и др. СОЛОН-ПРЕСС. 2002. 512 с.]. Первые эффективные полевые транзисторы были разработаны в СССР.
Почти все выпускаемые IGBT являются n-канальными транзисторами. Теоретически, не существует существующих p-канальных IGBT транзисторов из-за отсутствия рыночного спроса.
Основными преимуществами IGBT являются
– Высокая мощность переключения;
– Высокие рабочие напряжения;
– Устойчивость к токовым перегрузкам;
– Низкие контрольные мощности.
Области применения IGBT транзисторов:
– В импульсных преобразователях мощности и инверторах (свыше 1 кВт);
– В системах индукционного нагрева;
– В системах управления двигателями (частотно-регулируемые приводы).
Поэтому IGBT-транзисторы используются только в качестве ключевых компонентов.
Во многих случаях IGBT содержат встроенный высокоскоростной диод обратной связи.
Идентификация и внутренняя конструкция IGBT-транзистора
Условная и эквивалентная упрощенная внутренняя структура IGBT и реальная эквивалентная схема показаны на следующем рисунке.
Рисунок IGBT.1 – Идентификация и эквивалентная упрощенная внутренняя структура IGBT транзистора и реальная эквивалентная схема.
В некоторых типах IGBT встроен отдельный быстрый обратный диод.
Основные параметры IGBT-транзистора следующие
Ниже приведены основные параметры IGBT-транзистора, указанные в технических описаниях.
1. Максимальное напряжение коллектор-эмиттер (напряжение коллектор-эмиттер или напряжение пробоя коллектор-эмиттер) ВCES – Максимально допустимое напряжение между коллектором и эмиттером транзистора. 2.
Напряжение насыщения коллектор-эмиттер VCE(on) – Падение напряжения между коллектором и эмиттером в открытом состоянии. При заданном токе коллектора и температуре.
3. Максимальное напряжение между затвором и излучателем ВGE – Максимальное управляющее напряжение от затвора к эмиттеру. Если это напряжение превышено, может произойти повреждение диэлектрика затвора и выход транзистора из строя.
4 Максимальный непрерывный ток коллектора IC – Максимальное значение тока коллектора, протекающего непрерывно. Фактически, для IGBT-транзисторов ток сильно зависит от температуры корпуса транзистора, и рабочий ток приведен для двух значений температуры – 25° C и 100° C.
5. Максимальный импульсный ток коллектора ICM – Максимальное значение импульсного тока коллектора. Зависит от коэффициента заполнения, условий теплоотдачи. Обычно ограничивается рассеиванием энергии через кристалл. 6.
Пороговое напряжение затвора VGE(th) – Напряжение на затворе, при котором транзистор начинает переходить в состояние проводимости.
7. температурный коэффициент напряжения пробоя ∆V(BR)CES/∆TJ – Коэффициент, определяющий максимальное напряжение коллектор-эмиттер, уменьшается с ростом температуры.
8. температураКоэффициент снижения порогового напряжения ∆VGE(th)/∆TJ – коэффициент, показывающий снижение порогового напряжения затвора с ростом температуры.
9.Нулевое напряжение затвора Коллекторный ток ICES – Ток утечки через коллекторный переход, когда транзистор выключен.
10.Падение напряжения на прямом диоде VFM – Фронтальное падение напряжения на диоде быстрой обратной связи, встроенном в транзистор.
Энергия лавины одиночного импульса EAS – Максимальная энергия, которая может быть рассеяна на кристалле транзистора без его разрушения. 12.
Максимальная рассеиваемая мощность PD – Максимальная тепловая мощность, которая может быть рассеяна от корпуса транзистора (при заданной температуре корпуса транзистора).
13) Диапазон рабочих температур – диапазон температур, в котором может работать транзистор.
14. Тепловое сопротивление между транзистором и воздухом RθJA . (Junction-to-Ambient) – максимальное тепловое сопротивление транзистора по отношению к воздуху (при условии свободной конвективной теплопередачи).
Тепловое сопротивление кристалла транзистора относительно корпуса транзистора (Junction-to-Case – IGBT) RθJC – максимальное термическое сопротивление перехода кристалла транзистора к корпусу транзистора.
16. Тепловое сопротивление транзистора с переходом от перехода к корпусу (Переход от стыка к корпусу – диод) RθJC– максимальное тепловое сопротивление кристалла диода-транзистора между спаем и корпусом.
17. ток утечки между затвором и эмиттером IGES – Ток затвора при определенном (обычно максимальном) напряжении между затвором и истоком.
18. Общий сбор за проход Q.g – общий заряд затвора, необходимый для перевода транзистора в состояние проводимости. 19.
19. Заряд затвора – эмиттера (заряд затвора – эмиттера) Qge – Заряд емкости затвор – эмиттер.
20. заряд затвора – коллектора (Gate – Collector Charge) Qgc – Емкостной заряд коллектора затвора.
21. Время задержки включения td(on) – Время, необходимое транзистору для накопления заряда затвора, после чего транзистор начинает открываться.
22. Время нарастания – время, необходимое для увеличения коллекторного тока транзистора с 10% до 90%.
23. время задержки выключения td(off) – Время, в течение которого заряд затвора становится меньше заряда включения и транзистор начинает закрываться.
24. Время спада – время спада коллекторного тока транзистора с 10% до 90%.
25. Коммутационные потери транзистора во включенном состоянии E.на стр. – Энергия, рассеиваемая в кристалле во время переходного процесса переключения транзистора при заданном напряжении коллектор-эмиттер, напряжении на затворе и токе коллектора.
26. Коммутационные потери при выключении транзистора E.за пределами – Энергия, рассеиваемая в интегральной схеме во время переходного процесса переключения при заданном напряжении коллектор-эмиттер, напряжении на затворе и токе коллектора.
27. общие коммутационные потери Eц– Общие потери на переключение в цикле включения-выключения транзистора для заданного напряжения коллектор-эмиттер, напряжения на затворе и тока коллектора.
28. Максимальная скорость нарастания напряжения исток-сток (dv/dt ruggedness) – максимальная скорость нарастания напряжения исток-сток, при которой транзистор еще не находится в проводящем состоянии. 29.
29 Внутренняя индуктивность эмиттера L.E – Паразитная индуктивность эмиттерного конца транзистора.
30. максимальная пиковая скорость поглощения регенерации диода (di(rec)M/dt) – максимальная скорость спада тока интегрального диода при переходе его в непроводящее состояние из-за смены полярности.
31 Непрерывный ток диода исток-сток IS – Максимальное значение непрерывного прямого тока, протекающего через паразитный p-n диод.
32. импульсный прямой ток диода ISM – Максимальное значение постоянного прямого тока, протекающего через паразитный p-n диод.
33. напряжение на корпусе диода (напряжение на корпусе диода) VSD – Прямое падение напряжения на диоде. При заданной температуре и токе источника.
34. Время обратной регенерации корпусного диода trr – время восстановления обратной проводимости паразитного диода.
35. обратный заряд диода корпуса (обратный заряд) Qrr – Заряд, необходимый для восстановления обратной проводимости корпусного диода.
36. время включения (tна стр. – Время перехода диода в состояние проводимости. Обычно не имеет значения.
37. входная емкость (Input Capacitance) C – Сумма емкостей затвор-коллектор и затвор-эмиттер (при заданном напряжении коллектор-эмиттер).
Выходная емкость Coes – Сумма емкостей затвор-коллектор и коллектор-эмиттер (при определенном напряжении коллектор-эмиттер).
Емкость обратной передачи Cres – Емкость затвор-коллектор.
Паразитная емкость IGBT-транзистора
Паразитная емкость IGBT (рис. IGBT.2) является причиной снижения производительности IGBT.
Рисунок IGBT.2 – Паразитная емкость в IGBT транзисторе
Классификация IGBT по скорости переключения
IGBT транзисторы классифицируются на четыре группы в соответствии с их скоростью переключения, как показано в таблице IGBT.1:
Таблица IGBT.1 Классификация IGBT-транзисторов по скорости переключения [Эффективные и способные IGBT-транзисторы седьмого поколения от IR. Донцов Александр. Силовая электроника №5, 2013].
Чем выше частота модуляции, тем точнее воспроизводится синусоида, но чем выше потери на переключение, тем больше нагревается радиатор модуля и тем больше возникает радиочастотных помех. Чем ниже частота модуляции, тем проще работа модуля IGBT, но тем больше гармоник тока в цепи питания и его реактивной мощности. Поэтому пользователь может выбирать частоту модуляции ШИМ в диапазоне 2…16 кГц (у разных моделей частотных регуляторов разные диапазоны) дискретно с шагом в несколько ступеней.
IGBT-модули
Поскольку IGBT, как правило, очень редко используются в единственном исполнении, разработчики начали задумываться о модульных вариантах их схем. Модульные конструктивно намного проще и компактнее для использования в изделиях. Но не только это.
Очень важной функцией IGBT-модулей является то, что они могут увеличивать мощность преобразователей частоты, инверторов без больших материальных затрат!
Преобразователь частоты малой мощности с расширенными функциями управления стоит гораздо дешевле, чем преобразователь частоты большой мощности. Эффективный модуль IGBT стоит недешево, но эффективный модуль IGBT и недорогой, но “умный” преобразователь частоты могут обойтись в несколько раз дешевле. Потребителям (и производителям) есть о чем подумать.
Однако это потребует вмешательства квалифицированных инженеров, поскольку инверторы придется подключать заново, так как не все модели допускают такое расширение: для таких подключений нет никаких выходов, и в руководстве по эксплуатации ничего нет, кроме, возможно, запрета на вмешательство в цепи инвертора со стороны потребителей и отказа от ответственности в таких случаях. Помимо технической стороны дела, существует также возможная юридическая сторона: возможное нарушение патентов, лицензий и т.д. Это также следует иметь в виду.
Рисунок 1: Структура IGBT различных технологий
Заключение
В этой статье описаны и систематизированы достижения компании Infineon. Однако не следует забывать, что они образуют комплексное решение, элементы которого нельзя рассматривать по отдельности. Нет смысла использовать технологию .XT в модулях с низкотемпературными кристаллами (если вы не хотите обеспечить их долговечность) или использовать транзисторы пятого поколения с более толстыми медными эмиттерами в качестве отдельных устройств в стандартных корпусах.
В любом случае, цель, поставленная Infineon, достигнута, и разработчикам мощных транзисторов есть чему поучиться и что освоить. Новые цели, технологии и рекорды, похоже, не за горами, поскольку технологии преобразования энергии все еще находятся на ранних стадиях раскрытия своего потенциала.
- Принцип работы транзисторов Мосфета.
- Биполярные транзисторы.
- Что такое полевой транзистор и как его проверить.
- Как работает транзистор.
- Шаговые двигатели: свойства и практические схемы управления. Часть 2.
- Полупроводниковые диоды.
- Транзисторный ключ.